Управление мощной нагрузкой постоянного тока. Часть 3.
Кроме транзисторов и сборок Дарлингтона есть еще один хороший способ рулить мощной постоянной нагрузкой — полевые МОП транзисторы.
Полевой транзистор работает подобно обычному транзистору — слабым сигналом на затворе управляем мощным потоком через канал. Но, в отличии от биполярных транзисторов, тут управление идет не током, а напряжением.
МОП (по буржуйски MOSFET) расшифровывается как Метал-Оксид-Полупроводник из этого сокращения становится понятна структура этого транзистора.
Если на пальцах, то в нем есть полупроводниковый канал который служит как бы одной обкладкой конденсатора и вторая обкладка — металлический электрод, расположенный через тонкий слой оксида кремния, который является диэлектриком. Когда на затвор подают напряжение, то этот конденсатор заряжается, а электрическое поле затвора подтягивает к каналу заряды, в результате чего в канале возникают подвижные заряды, способные образовать электрический ток и сопротивление сток — исток резко падает.
Достоинство такого транзистора, по сравнению с биполярным очевидно — на затвор надо подавать напряжение, но так как там диэлектрик, то ток будет нулевым, а значит требуемая мощность на управление этим транзистором будет мизерной
Недостаток же вытекает из его емкостного свойства — наличие емкости на затворе требует большого зарядного тока при открытии. В теории, равного бесконечности на бесконечно малом промежутки времени. А если ток ограничить резистором, то конденсатор будет заряжаться медленно — от постоянной времени RC цепи никуда не денешься.
МОП Транзисторы бывают P и N канальные. Принцип у них один и тот же, разница лишь в полярности носителей тока в канале. Соответственно в разном направлении управляющего напряжения и включения в цепь. Очень часто транзисторы делают в виде комплиментарных пар. То есть есть две модели с совершенно одиннаковыми характеристиками, но одна из них N, а другая P канальные. Маркировка у них, как правило, отличается на одну цифру.
Соответственно в разном направлении управляющего напряжения и включения в цепь. Очень часто транзисторы делают в виде комплиментарных пар. То есть есть две модели с совершенно одиннаковыми характеристиками, но одна из них N, а другая P канальные. Маркировка у них, как правило, отличается на одну цифру.
Нагрузка включается в цепь стока. Вообще, в теории, полевому транзистору совершенно без разницы что считать у него истоком, а что стоком — разницы между ними нет. Но на практике есть, дело в том, что для улучшения характеристик исток и сток делают разной величины и конструкции плюс ко всему, в мощных полевиках часто есть обратный диод (его еще называют паразитным, т.к. он образуется сам собой в силу особенности техпроцесса производства).
У меня самыми ходовыми МОП транзисторами являются IRF630 (n канальный) и IRF9630 (p канальный) в свое время я намутил их с полтора десятка каждого вида. Обладая не сильно габаритным корпусом TO-92 этот транзистор может лихо протащить через себя до 9А. Сопротивление в открытом состоянии у него всего 0.35 Ома.
Обладая не сильно габаритным корпусом TO-92 этот транзистор может лихо протащить через себя до 9А. Сопротивление в открытом состоянии у него всего 0.35 Ома.
Впрочем, это довольно старый транзистор, сейчас уже есть вещи и покруче, например IRF7314, способный протащить те же 9А, но при этом он умещается в корпус SO8 — размером с тетрадную клеточку.
Одной из проблем состыковки MOSFET транзистора и микроконтроллера (или цифровой схемы) является то, что для полноценного открытия до полного насыщения этому транзистору надо вкатить на затвор довольно больше напряжение. Обычно это около 10 вольт, а МК может выдать максимум 5.
Тут вариантов три:
- На более мелких транзисторах сорудить цепочку, подающую питалово с высоковольтной цепи на затвор, чтобы прокачать его высоким напряжением
- применить специальную микросхему драйвер, которая сама сформирует нужный управляющий сигнал и выровняет уровни между контроллером и транзистором.

Надо только не забывать, что есть драйверы верхнего и нижнего плеча (или совмещенные, полумостовые). Выбор драйвера зависит от схемы включения нагрузки и комутирующего транзистора. Если обратишь внимание, то увидишь что с драйвером и в верхнем и нижнем плече используются N канальные транзисторы. Просто у них лучше характеристики чем у P канальных. Но тут возникает другая проблема. Для того, чтобы открыть N канальный транзистор в верхнем плече надо ему на затвор подать напряжение выше напряжения стока, а это, по сути дела, выше напряжения питания. Для этого в драйвере верхнего плеча используется накачка напряжения. Чем собственно и отличается драйвер нижнего плеча от драйвера верхнего плеча.
- Применить транзистор с малым отпирающим напряжением.
 Например из серии IRL630A или им подобные. У них открывающие напряжения привязаны к логическим уровням. У них правда есть один недостаток — их порой сложно достать. Если обычные мощные полевики уже не являются проблемой, то управляемые логическим уровнем бывают далеко не всегда.
Например из серии IRL630A или им подобные. У них открывающие напряжения привязаны к логическим уровням. У них правда есть один недостаток — их порой сложно достать. Если обычные мощные полевики уже не являются проблемой, то управляемые логическим уровнем бывают далеко не всегда.
Выбор транзистора тоже не очень сложен, особенно если не заморачиваться на предельные режимы. В первую очередь тебя должно волновать значение тока стока — I Drain или ID выбираешь транзистор по максимальному току для твоей нагрузки, лучше с запасом процентов так на 10. Следующий важный для тебя параметр это 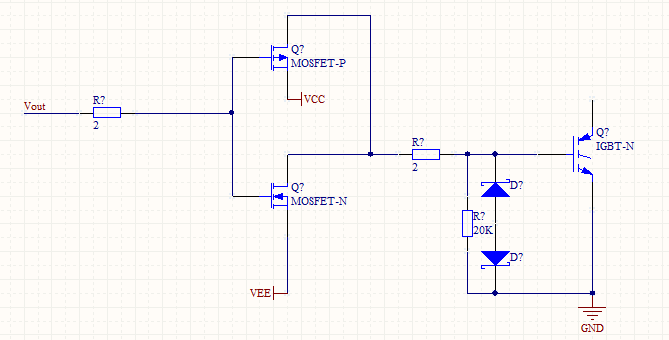 Иногда его пишут, но чаще приходится выглядывать из графиков. Ищешь график выходной характеристики Зависимость ID от VDS при разных значениях VGS. И прикидыываешь какой у тебя будет режим.
Иногда его пишут, но чаще приходится выглядывать из графиков. Ищешь график выходной характеристики Зависимость ID от VDS при разных значениях VGS. И прикидыываешь какой у тебя будет режим.
Вот, например, надо тебе запитать двигатель на 12 вольт, с током 8А. На драйвер пожмотился и имеешь только 5 вольтовый управляющий сигнал. Первое что пришло на ум после этой статьи — IRF630. По току подходит с запасом 9А против требуемых 8. Но глянем на выходную характеристику:
Видишь, на 5 вольтах на затворе и токе в 8А падение напряжения на транзисторе составит около 4.5В По закону Ома тогда выходит, что сопротивление этого транзистора в данный момент 4.5/8=0.56Ом. А теперь посчитаем потери мощности — твой движок жрет 5А. P=I*U или, если применить тот же закон Ома, P=I2R.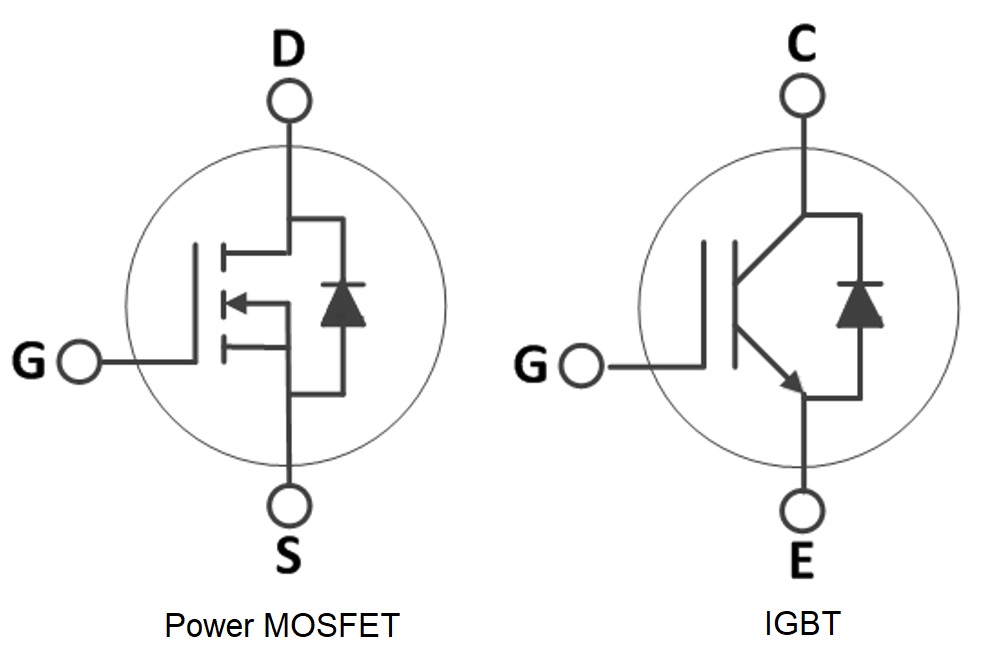 При 8 амперах и 0.56Оме потери составят 35Вт. Больно дофига, не кажется? Вот и мне тоже кажется что слишком. Посмотрим тогда на
При 8 амперах и 0.56Оме потери составят 35Вт. Больно дофига, не кажется? Вот и мне тоже кажется что слишком. Посмотрим тогда на
При 8 амперах и 5 вольтах на Gate напряжение на транзисторе составит около 3 вольт. Что даст нам 0.37Ом и 23Вт потерь, что заметно меньше.
Если собираешься загнать на этот ключ ШИМ, то надо поинтересоваться временем открытия и закрытия транзистора, выбрать наибольшее и относительно времени посчитать предельную частоту на которую он способен. Зовется эта величина Switch Delay или ton,toff, в общем, как то так. Ну, а частота это 1/t. Также не лишней будет посмотреть на емкость затвора  Если постоянная времени будет больше чем период ШИМ, то транзистор будет не открыватся/закрываться, а повиснет в некотором промежуточном состоянии, так как напряжение на его затворе будет проинтегрировано этой RC цепью в постоянное напряжение.
Если постоянная времени будет больше чем период ШИМ, то транзистор будет не открыватся/закрываться, а повиснет в некотором промежуточном состоянии, так как напряжение на его затворе будет проинтегрировано этой RC цепью в постоянное напряжение.
При обращении с этими транзисторами учитывай тот факт, что статического электричества они боятся не просто сильно, а ОЧЕНЬ СИЛЬНО
А в процессе проектирования схемы запомни еще одно простое правило — ни в коем случае нельзя оставлять висеть затвор полевика просто так — иначе он нажрет помех из воздуха и сам откроется. Поэтому обязательно надо поставить резистор килоом на 10 от Gate до GND для N канального или на +V для P канального, чтобы паразитный заряд стекал. Вот вроде бы все, в следующий раз накатаю про мостовые схемы для управления движков.
Выбор полевого MOSFET транзистора для стола и экструдера — мануал по важным аспектам даташитов
Вместо твердотельного реле для управления питанием нагрева стола или экструдера альтернативным решением является использование полевых (MOSFET) транзисторов. Но какой из всего многообразия моделей и скудности ассортимента ближайшего магазина радиотоваров выбрать? Заказать на Али и ждать месяц? Или бегать по городу и искать ‘тот самый, как в инструкции’? Давайте попробуем разобраться.Сразу предупрежу — в радиотехнике и электронике я слабоват, так что если есть люди более компетентные с достаточным занием, то оставляйте коментарии, попробую дополнить. Все что здесь будет изложено — лишь перевод англоязычного источника.
Очевидно, что для выбора понадобится учесть параметры нагрузки — это напряжение и сила тока. Для 40 Ваттного нагревательного картриджа экструдера работающего от 12 В это примерно 3,33 А и при 24 В — 1,7 А. Для 150 Ваттного стола Prusa это будет 12,5 А при 12 В и 6,25 А при 24 В. 2 = 0,0158 Ω * 156,25 A = 2,47 Ватт
2 = 0,0158 Ω * 156,25 A = 2,47 Ватт
Теперь посмотрим на другой параметр Rθja — тепловое сопротивление Junction-to-Ambient. Оно измеряется в Градусах Цельсия на Ватт. Находим этот параметр в нашем даташите:
В случае SMD корпуса D2 (для модели IRFS3806PBF) это значение было бы 40 ℃/Вт, но для TO-220 (IRFB3806PBF) это значение будет 62 ℃/Вт.Теперь умножим мощность, которую необходимо рассеять на найденное значение:
2,47 Ватт * 62 ℃/Ватт = 153,14 ℃
Ого, уже выглядит не очень. Но и это не всё. Т.к. Junction-to-Ambient намекает нам на то, что мы имеем дело с окружающей средой, то было бы опрометчиво не добавить температуру окружающей транзистор среды — пусть будет 25℃. И в итоге получим температуру, до которой нагреется корпус нашего транзистора — нехилых 178,14℃!
Не то чтобы обеспечить достаточное охлаждение в таком случае совершенно невозможно, но в домашних условиях пытаться это сделать будет проблематично. Лучше подыскать что-то более подходящее. 2 = 0.0017 Ω * 156.25 A = 0,266 Вт
2 = 0.0017 Ω * 156.25 A = 0,266 Вт
И тогда температура корпуса транзистора будет:
0,266 Вт * 62 ℃/Ватт + 25 = 41,5 ℃
Вот это дело! Температура поднимется всего 41,5 ℃ при максимальных нагрузках, а при нормальных будет и того меньше — смотрим Rdss(on) typ. и получим 38,5 ℃. Отличный вариант! Именно этот транзистор был указан в мануале для сборки Ultimaker от Plastmaska.
Может быть америку тут не открыл, но надеюсь, эти две нехитрые формулы помогут вам выбрать подходящий полевой транзистор. Ну и не забываем, что у всех всё разное, без пересчёта под свои значения брать MOSFET из статьи не стоит.
Как подобрать замену для MOSFET-транзистора || AllTransistors.com
Для большинства MOSFET-транзисторов достаточно просто подобрать аналоги, схожие по параметрам. Если заменить неисправный MOSFET-транзистор на такой же невозможно, то для поиска аналога необходимо:
- Узнать полное наименование транзистора по его маркировке.
 Для MOSFET-транзистора в корпусе СМД название можно расшифровать
по маркировке: СМД-коды 🔗.
Для MOSFET-транзистора в корпусе СМД название можно расшифровать
по маркировке: СМД-коды 🔗.
- Изучить схему включения MOSFET-транзистора для определения режима его работы (ключ в цепях коммутации, импульсное устройство, линейный стабилизатор и т.д.).
- Найти даташит для неисправного MOSFET-транзистора и заполнить форму для подбора аналога на сайте.
- Выбрать наиболее подходящий аналог MOSFET-транзистора, учитывая режим его работы в устройстве.
На что нужно обратить внимание
Открыв PDF-даташит, в первую очередь надо выяснить: тип транзистора (MOSFET или JFET), полярность, тип корпуса, расположение выводов (цоколевку).
Из числовых параметров это, прежде всего предельные характеристики, такие как Pd — максимальная рассеиваемая мощность, Vds — максимальное напряжение
сток-исток, Vgs — максимальное напряжение затвор-исток, Id — максимальный ток стока. У подбираемого транзистора эти параметры должны быть не меньше чем у исходного транзистора.
Для MOSFET-транзистора важным параметром является сопротивление сток-исток открытого транзистора (Rds). От значения Rds зависит мощность, выделяемая на транзисторе. Чем меньше значение Rds, тем меньше транзистор будет нагреваться.
Однако необходимо помнить, что чем больше Id и меньше Rds, тем больше ёмкость затвора у MOSFET-транзистора. Это приводит к тому, что требуется большая мощность для управления этим затвором. А если схема не обеспечит нужную мощность, то возрастут динамические потери из-за замедленной скорости переключения транзистора и, как итог, MOSFET будет больше нагреваться. Поэтому необходимо проверить температурный режим (нагрев) транзистора после включения устройства. Если транзистор сильно нагревается, то дело может быть как в самом транзисторе, так и в элементах его обвязки.
Расшифровка основных параметров MOSFET-транзисторов
Тип транзистора – в реальных устройствах могут использоваться полевые транзисторы разных типов: транзистор с управляющим p-n – переходом (J-FET) или
униполярные транзисторы МДП-типа (MOSFET).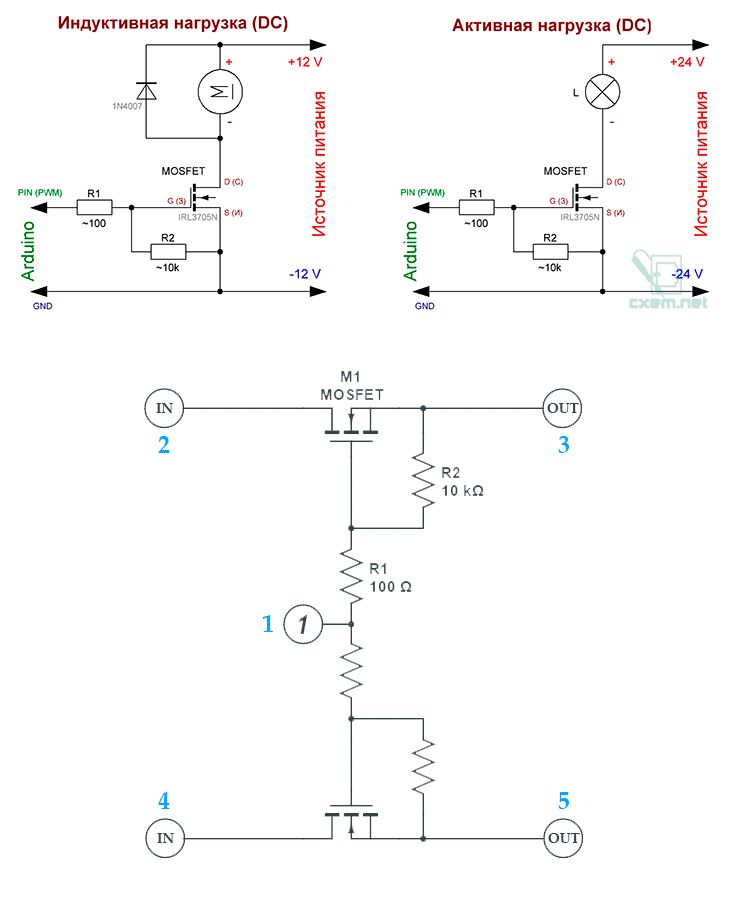
Полярность — полевые транзисторы могут быть прямой проводимости или обратной, то есть с P-каналом или N-каналом.
Максимальная рассеиваемая мощность (Pd) — необходимо убедиться, что выбранный транзистор может рассеивать достаточную мощность. Этот параметр зависит от максимальной рабочей температуры транзистора — при повышении температуры максимальная рассеиваемая мощность уменьшается. Если рассеиваемая мощность недостаточна — ухудшаются некоторые характеристики транзистора. Например, сопротивление Rds может удвоиться при возрастании температуры от 25°C до 125°C.
Предельно допустимое напряжение сток-исток (Vds) – это максимальное напряжение сток-исток не вызывающее лавинного пробоя при температуре 25°C. Оно имеет зависимость от температуры: напряжение уменьшаться при уменьшении температуры транзистора. Например, при -50°C, напряжение, не вызывающее лавинного пробоя, может составлять 90% от Vds при 25°C.
Предельно допустимое напряжение затвор-исток (Vgs) – при подаче на затвор напряжения более допустимого, возможно повреждение изолирующего оксидного слоя
затвора (это может быть и статическое электричество). Не стоит использовать транзисторы с большим запасом по напряжениям Vds и Vgs, т.к. обычно они имеют
худшие скоростные характеристики.
Не стоит использовать транзисторы с большим запасом по напряжениям Vds и Vgs, т.к. обычно они имеют
худшие скоростные характеристики.
Пороговое напряжение включения Vgs(th) — если напряжение на затворе выше Vgs(th), MOSFET транзистор начинает проводить ток через канал сток-исток. Vgs(th) имеет отрицательный температурный коэффициент: с увеличением температуры MOSFET-транзистор начинает открываться при более низком напряжении затвор-исток.
Максимально допустимый постоянный ток стока (Id) – следует иметь ввиду, что иногда выводы из корпуса транзистора ограничивают максимально допустимый постоянный ток стока (переключаемый ток может быть больше). С ростом температуры максимально допустимый ток уменьшается.
Максимальная температура канала (Tj) — этот параметр ограничивает температуру канала транзистора во включенном состоянии. Если ее превысить, срок службы транзистора может сократиться.
Общий заряд затвора (Qg) — заряд, который нужно сообщить затвору для открытия транзистора. Чем меньше этот параметр, тем меньшая мощность требуется для управления транзистором.
Чем меньше этот параметр, тем меньшая мощность требуется для управления транзистором.
Время нарастания (tr) — время, за которое ток стока увеличится с 10% до 90% от указанного.
Сопротивление сток-исток открытого транзистора (Rds) — сопротивление открытого канала сток-исток при заданных параметрах: Id, Vgs и Tj.
Выше описаны наиболее важные параметры MOSFET-транзисторов. В даташитах производитель указывает много дополнительных параметров: заряд затвора, ток утечки затвора, импульсный ток стока, входная емкость и др.
Что важно учесть при монтаже MOSFET-транзистора
При работе с MOSFET транзисторами нужно учесть, что они могут быть повреждены статическим электричеством на ваших руках или одежде. Перед монтажом
на печатную плату необходимо соединить выводы транзистора между собой тонкой проволокой. Для пайки лучше используйте паяльную станцию,
а не обычный электрический паяльник. Вместо отсоса для удаления припоя используйте медную ленту для удаления припоя. Это уменьшит вероятность
пробоя затвора статическим электричеством. Или используйте антистатический браслет.
Это уменьшит вероятность
пробоя затвора статическим электричеством. Или используйте антистатический браслет.
Транзиторы IGBT применяемые в сварках — Систематизированная полезная информация
Транзисторы IGBT применяемые в сварках
Просьба добавлять в данный список информацию
2SK4107 500V 15A 150W N-ch.TO-247
FGh50N60SFD 600V 40A 290W Vce=2.3V TO-247
FGh50N60UFD IXGh50N60C2 , IXGh58N60C3 600V 40A 290W Vce=1.8V TO-247
FGH60N60SFD IXGh50N60C2 , IXGh58N60C3 600V 60A 378W Vce=2. 3V TO-247
3V TO-247
G30N60 600V 30A TO-220
GW50NB60M SGW50N60HS 600V 50A TO-247
HGTG30N60A4 IRG4PC50W 600V 30A TO-247
HGTG30N60A4D IRG4PC50UD,SKW30N60HS 600V 30A TO-247AC с диодом
IRG4PC40W SGW20N60 600V 40A 65W TO-247
IRG4PC50UD 600V 55A 8-40 kHZ TO-247
IRG4PC50W SGW30N60 600V 55A TO247
IRGP4063D 600V 96A 330W ULTRAFAST T0-247
IRGP4068D IRGP4066D,RJH60F7ADPK 600V 96A 170W TO-247
IRGP50B60PD1 RJH60F5 600V 45A TO-247 с диодом
IXGh50N60B2D1 600V 75A 300W TO-247
SGB10N60A RGS10B60KDPBF,SKB15N60,IKB20N60T,HGT1S12N60A4DS 600V 10A Fast IGBT TO-263
С буквой D с диодом
MOSFET УСИЛИТЕЛЬ
Мало кто знает, что такое Мосфет, но почти все слышали, что это есть очень хорошо. Давайте сначала разберёмся с этим словом. MOSFET — английское сокращение от metal-oxide-semiconductor field effect transistor. Структура его состоит из металла и полупроводника, разделённых слоем диоксида кремния (SiO2). В общем случае структуру называют МДП (металл — диэлектрик — полупроводник).
Давайте сначала разберёмся с этим словом. MOSFET — английское сокращение от metal-oxide-semiconductor field effect transistor. Структура его состоит из металла и полупроводника, разделённых слоем диоксида кремния (SiO2). В общем случае структуру называют МДП (металл — диэлектрик — полупроводник).
Транзисторы на основе таких структур, в отличие от биполярных, управляются напряжением, а не током и называются униполярными транзисторами, так как для их работы необходимо наличие носителей заряда только одного типа. Высокая температурная стабильность, малая мощность управления, слабая подверженность к пробою, самоограничение тока стока, высокое быстродействие в режиме коммутации, малый уровень шума — это основные преимущества полевых MOSFET транзисторов перед радиолампами и биполярными транзисторами.
Большинство любителей высококачественного звуковоспроизведения оценивают усилитель на полевых MOSFET транзисторах на очень высоком уровне, практически как и ламповых, ведь по сравнению с усилителями на обычных биполярных транзисторах они выдают более мягкое звучание, создают меньше искажений и устойчивы к перегрузке. MOSFET превосходят классические ламповые усилители, как по коэффициенту демпфирования, так и по передаче низких и высоких частот. Частота среза таких усилителей значительно выше, чем у усилителя на биполярных транзисторах, что благоприятно сказывается на звуке.
MOSFET превосходят классические ламповые усилители, как по коэффициенту демпфирования, так и по передаче низких и высоких частот. Частота среза таких усилителей значительно выше, чем у усилителя на биполярных транзисторах, что благоприятно сказывается на звуке.
Мощные полевые MOSFET транзисторы имеют меньший разброс основных параметров, чем биполярные транзисторы, что как бы облегчает их параллельное включение и уменьшает общее выходное сопротивление усилителя мощности.
Схема простого MOSFET усилителя
Параметры усилителя
- Выходная мощность (RMS): 140 Вт при нагрузке 8 Ом, 200 Вт на 4 Ом.
- Частотный диапазон: 20 Гц — 80 кГц -1dB.
- Входная чувствительность: 800 mV при мощности 200 Вт на 4 Ом.
- Искажения: <0.1% (20 Гц — 20 кГц).
- Соотношение сигнал/шум: > 102dB невзвешенных, 105 дБ (A-взвешенное с учетом 200 Вт на 4 Ом).
На рисунке показана схема одного из самых простых УМЗЧ с применением полевых транзисторов этого типа в выходном каскаде. А мощность его составляет целых 200 ватт! Этот усилитель мощности MOSFET подходит для многих целей, таких как мощный концертный гитарник или домашний кинотеатр. Усилитель имеет хороший диапазон частот — от 1 дБ 20 Гц до 80 кГц. Коефициент искажений менее 0,1% при полной мощности, а соотношение сигнал/шум лучше, чем -100 dB. Дальнейшее упрощение возможно за счёт применения ОУ в предусилительном каскаде.
А мощность его составляет целых 200 ватт! Этот усилитель мощности MOSFET подходит для многих целей, таких как мощный концертный гитарник или домашний кинотеатр. Усилитель имеет хороший диапазон частот — от 1 дБ 20 Гц до 80 кГц. Коефициент искажений менее 0,1% при полной мощности, а соотношение сигнал/шум лучше, чем -100 dB. Дальнейшее упрощение возможно за счёт применения ОУ в предусилительном каскаде.
Вся конструкция УНЧ размещена в небольшом алюминиевом корпусе. Питается схема от простого двухполярного выпрямителя с тороидальным трансформаторомна 250 ватт. Обратите внимание, что на фото показан моноблок — то есть одноканальный усилитель, так как он собран для электрогитары.
Радиатор применён из черного анодированного алюминиевого профиля. Корпус имеет длинну 300 мм и снабжен сзади 80 мм вентилятором охлаждения. Вентилятор работает постоянно, поэтому радиатор всегда прохладный, даже при максимальной мощности (или, по крайней мере, несколько выше температуры окружающей среды).
Originally posted 2018-10-09 17:13:44. Republished by Blog Post Promoter
Быстрый IGBT с характеристиками переключения, как у полевого МОП-транзистора
Введение
Энергосберегающие государственные стандарты и снижение системных расходов — это главные движущие силы разработки более эффективных силовых ключей [1]. Разработчики вынуждены тщательно выбирать правильный ключ для соответствия обоим требованиям. В системах большой мощности (>5 кВт) обычно принято использовать IGBT или биполярные транзисторы. В маломощных (<2 кВт) системах на напряжения ниже 1000 В, с широким диапазоном входного напряжения и нагрузки, а также высокой частоте коммутации (>150 кГц), обычно предпочтение отдавалось полевым МОП-транзисторам. В импульсных источниках питания с жесткой коммутацией или коммутацией в нуле напряжения IGBT обычно применяется при более низкой частоте коммутации (<40 кГц) и там, где присутствует узкий диапазон изменения входного напряжения и нагрузки.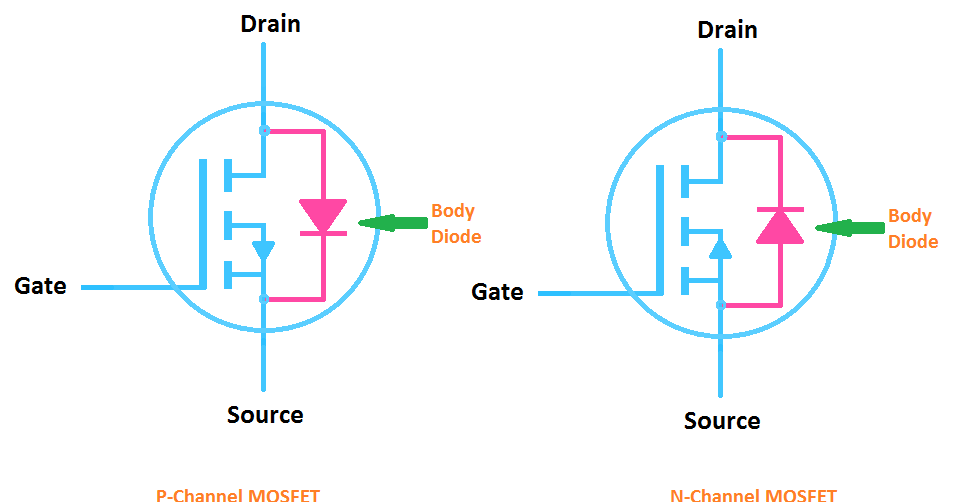
Типовыми областями применения для систем с жесткой коммутацией являются электроприводы, источники бесперебойного питания и сварочные аппараты. Хотя некоторые производители уже предлагают IGBT, разработанные для частот коммутации, даже превышающих 100 кГц, их применение несколько ограничено из-за трудности обеспечения высокого КПД в широком диапазоне нагрузок, как того требуют стандарты по энергосбережению. Использование частоты выше 40 кГц, тем не менее, наблюдается в резонансных схемах для индукционного нагрева и микроволновых печей благодаря применению мягкой коммутации в схемах ZVS и ZCS [3].
Современные поколения IGBT имеют две особенности, которые побуждают разработчиков расширять область применения, повышая рабочую частоту в схемах с жесткой коммутацией. Обычно размер чипа IGBT составляет 1/3 по сравнению с полевым МОП-транзистором с таким же номинальным током, что снижает емкость и заряд затвора для конструкции эквивалентной ячейки, а корреляция Vcesat–Eoff может быть отрегулирована для требуемой частоты переключения путем настройки относительно малого набора технологических и проектных параметров.
Новые семейства быстрых IGBT позволяют разработчикам повысить частоту коммутации мощных транзисторов без изменения требований к их охлаждению. Тем самым можно снизить общую стоимость системы за счет снижения стоимости силовых ключей, а также размеров и стоимости пассивных компонентов.
С такой мотивацией компания Infineon Technologies разработала третье поколение быстрых IGBT, оптимизированных для высокой частоты и режимов жесткой коммутации для таких областей применения, как сварочные аппараты, солнечная энергетика и источники бесперебойного питания (ИБП).
На частотах свыше 20 кГц потери на переключение обычно преобладают в общих потерях, и поэтому уменьшение Eon и Eoff без существенного ущерба для Vcesat было одной из целей разработки. Другая цель — для снижения электромагнитных помех и уменьшения размеров фильтров избежать затухающих колебаний и сохранить гладкость формы тока и напряжения в момент комутации с типичным для IGBT компании Infineon низким dV/dt и dI/dt.
Для уменьшения потерь Eoff при аппаратном переключении хвостовой ток при высокой температуре должен быть устранен, так как эти малые потери становятся особенно значимыми при высокой частоте переключения. Для снижения потерь Eon конструкция IGBT и обратный диод должны быть оптимизированы.
Технология TrenchStop
Для достижения этой цели, как и в большинстве семейств IGBT, недавно выпущенных компанией Infineon Technologies, выбрана технология Trench Field Stop [4, 5]. В отличие от наших конкурентов, которые создают быстрые IGBT по планарной технологии, мы доказали, что оптимизированная структура Trench Stop (рис. 1) все еще обеспечивает наилучшее соотношение цена/качество для применения с высокой частотой коммутации.
Рис. 1. TrenchStoр IGBT
Сочетание Trench-ячейки и структуры с блокирующим слоем позволяет подобрать концентрацию носителей внутри кристалла таким образом, что относительно более высокая плотность носителей вблизи канавочного затвора дает возможность уменьшить Vcesat, что подразумевает более высокую плотность тока и, следовательно, меньшую площадь кристалла и более низкую стоимость. С помощью современных технологий имплантации и отжига можно создать области с низким временем жизни носителей рядом с p-эмиттером на нижней стороне. В сочетании с пониженным легированием p-эмиттера на нижней стороне и оптимизированным блокирующим слоем это дает возможность производить быструю экстракцию носителей во время выключения и получить уменьшенные хвостовые токи при сохранении в целом мягкого режима выключения. Особое внимание с точки зрения технологии было уделено стабильности слабого эмиттера и, в результате, малому разбросу параметров ключей при отклонении параметров технологических процессов.
С помощью современных технологий имплантации и отжига можно создать области с низким временем жизни носителей рядом с p-эмиттером на нижней стороне. В сочетании с пониженным легированием p-эмиттера на нижней стороне и оптимизированным блокирующим слоем это дает возможность производить быструю экстракцию носителей во время выключения и получить уменьшенные хвостовые токи при сохранении в целом мягкого режима выключения. Особое внимание с точки зрения технологии было уделено стабильности слабого эмиттера и, в результате, малому разбросу параметров ключей при отклонении параметров технологических процессов.
Динамические характеристики
Поведение полученного прибора в момент коммутации сравнивалось с приборами, выполненными по стандартной технологии IGBT3 с TrenchStop и Coolmos C3 с аналогичным номинальным током (табл. 1) в режиме жесткой коммутации в полумостовой схеме на индуктивной нагрузке. Для всех приборов обратным диодом являлся карбид-кремниевый диод Шоттки на 8 А от компании Infineon.
Таблица 1. Сравнение h4 со стандартным TrenchStop IGBT и прибором Coolmos С3
| Прибор | Технология | Ic при 100 °C, А | Площадь кристалла, мм2 |
| SPW47N60C3 | Coolmos C3 | 30 | 69,3 |
| IKW30T60 | TrenchStop | 30 | 15,2 |
| IGW40N60h4 | High Speed 3 | 40 | 19,3 |
Coolmos C3 был выбран в качестве точки отсчета при тестировании ключевых характеристик. Результирующие осциллограммы процесса выключения показаны на рис. 2 и 3. Лабораторная установка для тестирования IGBT в полумостовой конфигурации не предназначалась для испытания Coolmos (вывод стока, как и другие паразитные индуктивности, должен быть уменьшен за счет специальных разъемов и оптимизированной разводки печатной платы). Поэтому для сравнения с Coolmos C3 сопротивление затвора Rg нужно было повысить (42 против 11 Ом) во избежание колебаний тока и напряжения.
Рис. 2. Осциллограммы выключения h4 и стандартного IGBT с TrenchStop
Осциллограммы тока в IGBT h4 ясно показывают полное отсутствие хвостового тока при высокой температуре (рис. 2), а характеристики переключения при выключении напоминают однополюсный прибор быстрого выключения, подобный Coolmos C3 (рис. 3). Энергия выключения снижена на 60% по сравнению со стандартным TrenchStop IGBT3 при росте Vcesat только на 25%.
Рис. 3. Осциллограммы выключения IGBT h4 и Coolmos C3
В рамках таких испытаний IGBT h4 с номинальным током 40 А на самом деле демонстрирует более высокую скорость спада тока (dI/dt) при выключении, чем Coolmos C3 с 30 А (2080 против 1000 А/мкс на приведенном графике), все еще обеспечивая мягкий характер коммутации и умеренный выброс напряжения в 100 В. В связи с более крутым ростом напряжения Coolmos C3 характеризуется на 17% более низким значением Eoff. Полное сравнение при разных значениях тока нагрузки показано на рис. 4.
Рис. 4. Зависимость Eoff от тока нагрузки
Тестирование приборов-«конкурентов» выполнялось на базе той же испытательной схемы и график результирующего соотношения Vcesat/Eoff показан на рис. 5.
Рис. 5. Оценка приборов-«конкурентов»
IGBT h4 обладает на 170 мВ ниже Vcesat и на 6% ниже Eoff, чем лучший из конкурентов. На графике ясно видно превосходство избранного проектного сочетания Trench-затвора и блокирующего слоя. Приборы IKP15N60T и IGW40N60h4 выполнены на базе одинаковой технологии TrenchStop и лежат на лучшей технологической кривой (пунктиром), обладая существенно сниженными значениями Vcesat и немного сниженными значениями Eoff по сравнению с Конкурентом А, выполненным по схеме планарный затвор + блокирующий слой. Прибор SKB15N60HS от Infineon и Конкурент B также являются высокоскоростными приборами, однако выполнены по технологии NPT (Non Punch Through), недостатком которой является существенно более высокое напряжение Vcesat.
Выбор диода
Для схем, в которых требуется наличие обратно-параллельного диода, высокоскоростной IGBT 3 включается в паре с 600-вольтовым диодом 3-го поколения, выполненным по технологии Emitter Controlled diode. При выборе размера кристалла мы приняли во внимание то, что в большинстве целевых областей применения, например в инверторах ИБП и солнечных батарях, поток энергии однонаправленный (например, от солнечной батареи в сеть переменного тока для солнечных инверторов). Это приводит к понижению загрузки диода по сравнению с загрузкой диодов в инверторах электроприводов с полумостовой конфигурацией, где в режиме торможения (cosφ< 0) наблюдается значительный рост температуры кристаллов диодов за счет потерь на прямую проводимость в диоде.
Другим важным отличием от систем электропривода является форма импульса тока, проходящего через IGBT: в типичных одно- и двухтранзисторных топологиях, например импульсных источниках питания, корректорах коэффициента мощности и сварочных аппаратах, обычно наблюдается треугольная или трапецеидальная форма тока. Из этого следует, что IGBT жестко включается с токами меньшими, чем токи выключения, и в результате обратный диод может быть рассчитан на меньшие номинальные значения токов, таким образом внося свой вклад в общее снижение коммутационных потерь.
Влияние различных диодов на поведение 30-амперного IGBT h4 при включении показано на рис. 6.
Рис. 6. Выбор диода для IGBT h4 на 30 А
Для того чтобы обеспечить реальные рабочие условия, мы установили ток нагрузки, равный половине номинального тока, так как при высокой частоте переключения может потребоваться некоторое снижение номинального тока. Из-за разного размера кристалла испытываемого прибора значения потерь Eoff были откалиброваны к общему номиналу тока. Хотя карбид-кремниевый диод обеспечивает 50% снижения потерь IGBT при включении, был выбран «15-амперный» Emcon3, который, с одной стороны, обеспечивает достаточно быстрое включение и, с другой стороны, позволяет сохранить более низкую стоимость изделия. Высокая устойчивость и большие возможности управления энергией диодов серии Emitter Controlled 3-го поколения позволяют повысить плотность коммутируемого тока. Присущая диоду мягкая коммутация дает возможность снизить Rgon, благодаря чему потери включения IGBT уменьшаются, а электромагнитные помехи остаются на низком уровне.
Распределение потерь
Распределение потерь мощности в транзисторе в реальной схеме было смоделировано для прибора с номинальным током 40 А при следующих условиях (рис. 7): Ic = 40 А, Vdc = 400 В, Rg,on = 6,9 Ом, Rg,off = 3,2 Ом, коэффициент заполнения — 0,5, Tj = 150 °C, fsw = 20 и 40 кГц, прямоугольный импульс с жесткой коммутацией (включение и выключение на полный ток). IGBT h4 обеспечивает на 10% и на 4% меньше потерь при частоте 20 и 40 кГц соответственно, по сравнению с лучшим конкурентом, благодаря снижению потерь Eoff. При частоте 20 кГц статические потери все еще вносят около 50% вклада в общие потери, поэтому и стандартный прибор IKW40N60T по TrenchStop-технологии демонстрирует аналогичные потери в связи с более низким напряжением Vcesat.
Рис. 7. Оценка распределения потерь для одного прибора в реальных условиях
Анализ ясно показывает, что для быстрых IGBT в коммутационных потерях на переключение преобладают потери Eon. Это указывает на направление дальнейшего совершенствования данных приборов.
Внутрисхемное испытание
Для того чтобы оценить работу быстрого IGBT3 в условиях быстрой коммутации, 20-А и 30-А приборы были испытаны в составе испытательной платы корректора коэффициента мощности, обычно используемой для замеров производительности приборов Coolmos в компании Infineon Technologies (рис. 8).
Рис. 8. Испытательная плата ККМ
Характеристики платы: максимальная нагрузка 1 кВт, выходное постоянное напряжение 400 В, диапазон входного переменного напряжения 115–230 В, ККМ работает в режиме непрерывного тока.
Контроллер позволяет изменять рабочую частоту от 60 до 300 кГц. Температура на корпусе испытуемого прибора поддерживается равной 40 °C с помощью сочетания нагревателя и управления вентилятором. Индуктивность дросселя корректора коэффициента мощности равна 1 мкГн, а бустерным диодом для всех групп являлся 6-амперный карбид-кремниевый диод Шоттки IDT06S60C. Источник переменного тока — Chroma 6530, а нагрузка постоянного тока — Chroma 63202. КПД измерялся с помощью анализатора мощности Siemens B6040.
IGBT h4 сравнивался с прибором Coolmos C3 и другим обычным (не имеющим суперперехода) полевым МОП-транзистором компании-конкурента (табл. 2).
Таблица 2. Приборы, выбранные для испытания в схеме ККМ
| Прибор | Описание | Площадь кристалла, мм2 |
| IGP20N60h4 | IGBT h4 20 А – TO220 | 10,2 |
| IGP30N60h4 | IGBT h4 30 А – TO220 | 13,2 |
| SPW47N60C3 | Coolmos C3, 70 мОм – TO247 | 69,3 |
| SPP24N60C3 | Coolmos C3, 160 мОм – TO220 | 30,2 |
| Конкурент X | Станд. МОП: 130 мОм – PlusTO247 | 151,9 |
| Конкурент Y | Станд. МОП: 150 мОм – TO264 | 72,8 |
В связи с относительно большим размером кристаллов этих приборов выполнялись только испытания при низком входном напряжении (115 В). Даже в этом случае при максимальной выходной мощности 1 кВт выходной ток составляет около 10 А, что составляет 1/2–1/3 от номинального тока выбранных приборов. Результаты приведены на рис. 9 и 10.
Рис. 9. Измерение КПД ККМ при 60 кГц
Рис. 10. Измерение КПД ККМ при 100 кГц
При работе на частоте 100 кГц выходная мощность была ограничена 600 Вт для ограничения температуры прибора. Прибор Coolmos C3 на 70 мОм, лучший в классе корпусов TO247, показывает самый высокий КПД при токе нагрузки более 600 Вт. IGBT h4 в корпусе TO220 явно превосходит обычные полевые МОП-транзисторы в больших по размеру корпусах при работе как на частоте 60, так и 100 кГц, используя от 1/7 до 1/10 площади кристалла. Несмотря на в два раза меньшую площадь кристалла, IGBT h4 превосходит по производительности Coolmos C3 на 160 мОм при работе на мощностях выше 850 Вт, ясно показывая преимущество этой технологии быстрого IGBT с точки зрения плотности мощности и выявляя экономичное решение для ККМ на мощности более 1 кВт (например, в импульсных источниках питания телекоммуникационного назначения). Благодаря более низким значениям Vcesat и Rthjc, при работе на частоте 60 кГц IGBT h4 на 30 А обеспечивает некоторое преимущество над 20-амперным на большей нагрузке.
Осциллограммы переключения, зафиксированные во время испытания при работе на частоте 60 кГц, показаны на рис. 11.
Рис. 11. Осциллограммы выключения
При внешнем сопротивлении затвора, равном 4,7 Ом, IGBT h4 демонстрирует мягкую коммутацию тока в отсутствие затухающих или простых колебаний, а также в отсутствие выброса напряжения, что позволяет говорить о понижении уровня электромагнитных помех. Несмотря на больший размер кристалла, требуется малое значение Rg для минимизации времени переключения, Coolmos и обычный МОП показывают быстрое выключение при достаточно большом сопротивлении затвора. Благодаря мягким коммутационным характеристикам быстрого IGBT 3 появилась возможность уменьшения резистора затвора, что в свою очередь выражается в снижении потерь и приводит к уменьшению стоимости системы за счет упрощения охлаждения и фильтрации.
Заключение
Представлен новый высокоскоростной IGBT 3 на 600 В компании Infineon Technologies, получивший обозначение h4. Новый прибор обеспечивает эталонную производительность и является экономичным решением для применения в солнечной энергетике, ИБП, сварочных аппаратах и импульсных источниках питания. Динамические характеристики показывают полное отсутствие хвостового тока даже при повышенных температурах, что делает выключение похожим на поведение прибора Coolmos. Тип и номинал обратно-параллельлного диода выбирались на основе требований целевых областей применения. Наконец, внутрисхемная оценка, выполненная на испытательной плате ККМ, показала более высокую производительность по сравнению с обычными полевыми МОП-транзисторами с гораздо большими размерами кристалла при работе в широком диапазоне нагрузок. Плавное переключение при отсутствии колебаний тока и выбросов напряжения даже при низком сопротивлении затвора делают IGBT h4 оптимальным решением для улучшения производительности систем и снижения их стоимости.
Литература
- Примеры энергосберегающих стандартов:
- Kimmer T., Oehmen J., Tuerkes P., Voss S. Reverse Conducting IGBT. A new Technology to Increase the Energy Efficiency of Induction Cookers // Power Electronics Specialists Conference, PESC. 2008.
- Laska T., Munzer M., Pfirsch F., et al. The Field Stop IGBT: a new Power Device Concept with a Great Improvement Potential // Proceedings ISPSD, 2000.
- Ruthing H., Umbach F., Hellmund O., et al. 600V-IGBT3: Trench Field Stop Technology in 70 μm Ultra Thin Wafer Technology // Proceedings ISPSD, 2003.
В чем разница между MOSFET и IGBT
Сводка
Эта статья в основном посвящена различиям между MOSFET и IGBT, включая их соответствующие преимущества и недостатки и разницу в структуре, как выбрать MOSFET или IGBT и т. Д. Кроме того, производительность восстановления диода является основным фактором, который определяет MOSFET или потери переключения в открытом состоянии IGBT, поэтому мы также обсудим влияние восстановления диода на топологию жесткого переключения.
Каталог
I Различия в структуре между MOSFET и IGBT
Из-за структуры полевого МОП-транзистора он обычно может достигать большого тока и может достигать KA, но предварительным условием является то, что допустимое напряжение невысокое.Давайте сначала посмотрим видео о том, в чем разница между MOSFET и IGBT.
Это видео представляет собой простое описание разницы между IGBT, MOSFET, BJT
II Разница в мощности между MOSFET и IGBT
IGBT может обеспечить большую мощность, ток и напряжение, однако частота не слишком высоко. Текущая скорость жесткого переключения IGBT может достигать 100 кГц, это уже хорошо. Однако по сравнению с рабочей частотой полевого МОП-транзистора это все еще капля в море, полевой МОП-транзистор может работать до сотен кГц, МГц и даже до десятков МГц, RF-продуктов.
МОП-транзистор против IGBT
III Преимущества и недостатки MOSFET и IGBT
3.1 MOSFET
MOSFET представляет собой полностью управляемый переключатель с тремя выводами (затвор, сток и исток). Сигнал затвора / управления возникает между затвором и истоком, а его выводы переключателя являются стоком и истоком. Сам затвор выполнен из металла, отделен от истока и стока с помощью оксида металла. Это позволяет снизить энергопотребление и делает транзистор отличным выбором для использования в качестве электронного переключателя или усилителя с общим источником.Для правильной работы полевые МОП-транзисторы должны поддерживать положительный температурный коэффициент. Это означает, что вероятность теплового разгона практически отсутствует. Потери в открытом состоянии ниже, поскольку сопротивление транзистора в открытом состоянии, теоретически, не имеет ограничений. Кроме того, поскольку полевые МОП-транзисторы могут работать на высоких частотах, они могут выполнять приложения быстрого переключения с небольшими потерями при выключении.
Существует много различных типов полевых МОП-транзисторов, но наиболее сопоставимым с IGBT является силовой полевой МОП-транзистор.Он специально разработан для работы со значительными уровнями мощности. Они используются только в состояниях «включено» или «выключено», что привело к тому, что они являются наиболее широко используемыми переключателями низкого напряжения. По сравнению с IGBT, силовой MOSFET имеет преимущества более высокой скорости коммутации и большей эффективности при работе при низких напряжениях. Более того, он может выдерживать высокое напряжение блокировки и поддерживать высокий ток. Это связано с тем, что большинство структур силовых полевых МОП-транзисторов являются вертикальными (а не планарными). Его номинальное напряжение напрямую зависит от легирования и толщины N-эпитаксиального слоя, а его номинальный ток зависит от ширины канала (чем шире канал, тем выше ток).Благодаря своей эффективности силовые полевые МОП-транзисторы используются в источниках питания, преобразователях постоянного / постоянного тока и контроллерах двигателей низкого напряжения.
3.2 IGBT
IGBT также является полностью управляемым переключателем с тремя выводами (затвор, коллектор и эмиттер). Его сигнал затвора / управления проходит между затвором и эмиттером, а его выводы переключателя являются стоком и эмиттером. Он сочетает в себе простые характеристики управления затвором, присущие полевому МОП-транзистору, с высокой силой тока и низким напряжением насыщения биполярного транзистора.Это достигается за счет использования изолированного полевого транзистора с затвором для управляющего входа и биполярного силового транзистора в качестве переключателя. Более того, IGBT специально разработан для быстрого включения и выключения. Фактически, его частота следования импульсов попадает в ультразвуковой диапазон. Благодаря этой уникальной возможности IGBT часто используются с усилителями для синтеза сигналов сложной формы с широтно-импульсной модуляцией и фильтрами нижних частот. Они также используются для генерации мощных импульсов в таких областях, как физика элементарных частиц и плазмы, и зарекомендовали себя в современной технике, такой как электромобили, поезда, холодильники с регулируемой скоростью, кондиционеры и многое другое.Более подробно вы можете увидеть в этой статье «MOSFET vs. IGBT».
IV Характеристики применения MOSFET и IGBT
Что касается его применения, в соответствии с его характеристиками: MOSFET используется в импульсном источнике питания (вы можете ознакомиться с этим документом «Принцип работы мощной регулируемой коммутируемой мощности Поставка «, балласт, высокочастотный индукционный нагрев, высокочастотный инверторный сварочный аппарат, источник питания связи и так далее высокочастотный источник питания.IGBT специализируется на сварке, инверторах, инверторах, источниках питания для электролитического покрытия, сверхзвуковом индукционном нагреве и других областях.
Производительность импульсного источника питания (SMPS) сильно зависит от выбора силовых полупроводниковых устройств, а именно переключателя и выпрямителя.
Импульсный источник питания MOSFET
Хотя не существует комплексного решения проблемы выбора IGBT или MOSFET, сравнивая производительность IGBT и MOSFET в конкретных приложениях SMPS, все же возможно определить диапазон ключевых параметров.
Потеря проводимости в MOSFET и IGBT
Помимо более длительного падения напряжения IGBT, характеристики проводимости IGBT и силового MOSFET очень похожи. Из базовой эквивалентной схемы IGBT (см. Рисунок 1) можно увидеть, что время, необходимое для полной регулировки неосновных носителей в области базы коллектора PNP BJT, приводит к появлению скачка напряжения.
Рисунок 1: Эквивалентная схема IGBT
Эта задержка вызывает эффект квазинасыщения, так что напряжение коллектора / эмиттера не сразу падает до значения VCE (насыщение).Этот эффект также вызывает повышение напряжения VCE в случае ZVS в тот момент, когда ток нагрузки переключается с шунтирующего антипараллельного диода корпуса на коллектор IGBT.
Энергопотребление Eon, указанное в таблице данных IGBT, является интегралом по времени произведения Icollector и VCE для каждого цикла преобразования в Джоулях и содержит дополнительные потери, связанные с насыщением класса. Далее он делится на два энергетических параметра Eon: Eon1 и Eon2. Eon1 не включает потери мощности, связанные с потерями в диоде с жестким переключением, а Eon2 включает энергию включения жесткого переключения, связанную с восстановлением диода, которая может быть измерена путем восстановления того же диода, что и диод в диодной упаковке.Обычно тестовая схема Eon2 показана на рисунке 2. IGBT измеряет Eon путем включения и выключения двумя импульсами. Первый импульс увеличивает ток катушки индуктивности для достижения желаемого испытательного тока, а затем второй импульс измеряет потери Eon, при которых испытательный ток восстанавливается на диоде.
Рисунок 2: Типовая схема испытания Eon при включенном и выключенном Eoff
Потери при переключении Eon определяются напряжением и сопротивлением затвора, а также характеристиками восстановления выпрямительного диода при жестком включении.Для традиционных схем CCM с повышающим коэффициентом усиления PFC функция восстановления повышающего диода чрезвычайно важна для управления энергопотреблением Eon (on). Помимо выбора повышающего диода с минимальными значениями Trr и QRR, важно также обеспечить характеристики мягкого восстановления диода. Мягкость, соотношение tb / ta, оказывает значительное влияние на электрические шумы и скачки напряжения, создаваемые переключающими устройствами.
Некоторые быстродействующие диоды имеют высокую скорость падения тока (di / dt) от IRM (REC) в течение времени tb, вызывая выбросы высокого напряжения в паразитной индуктивности схемы.Эти скачки напряжения могут вызвать электромагнитные помехи (EMI) и вызвать чрезмерное обратное напряжение на диоде.
В схемах с жесткой коммутацией, таких как полумостовая и полумостовая топологии, пакеты, упакованные с IGBT, представляют собой транзисторы с быстрым восстановлением или корпусные диоды MOSFET. Когда соответствующий переключатель работает, через диод протекает ток, и характеристики восстановления диода определяют потери Eon. Поэтому очень важно выбрать MOSFET с характеристикой быстрого восстановления основного диода.К сожалению, характеристики восстановления паразитного диода или основного диода полевого МОП-транзистора ниже, чем у дискретных диодов, используемых в настоящее время в промышленности. Следовательно, для приложений MOSFET с жестким переключением внутренний диод часто является ограничивающим фактором, определяющим рабочую частоту SMPS.
Как правило, диоды в корпусе IGBT выбираются в соответствии с их применением, с более медленными сверхбыстродействующими диодами с меньшими потерями прямой проводимости и более медленными корпусами IGBT с моторным приводом с низким VCE (насыщенным).Напротив, сверхбыстрый диод с мягким восстановлением может быть оснащен высокочастотной комбинацией IGBT с импульсным режимом SMPS2. Помимо выбора правильного диода, разработчики также могут контролировать потери Eon, регулируя импеданс источника включения затвора. Уменьшение импеданса источника возбуждения увеличит включение / выключение IGBT или MOSFET и уменьшит потери Eon. Необходимо снизить потери Eon и EMI, поскольку более высокое значение di / dt приводит к скачкам напряжения, увеличению излучаемых и кондуктивных электромагнитных помех. Для выбора правильного импеданса привода затвора в соответствии с требованиями di / dt при включении может потребоваться внутреннее тестирование и проверка схемы.Затем можно определить приблизительное значение кривой перехода MOSFET (см. Рисунок 3).
Рисунок 3: Передаточные характеристики полевого МОП-транзистора
Предполагая, что ток полевого транзистора увеличивается до 10 А при включении, напряжение затвора должно измениться с 5,2 В до 6,7 В, чтобы достичь значения 10 А в соответствии с кривой при 25 ° C на рисунке 3 со средним GFS 10. A / (6,7 В — 5,2 В) = 6,7 мОм.
Уравнение 1 дает импеданс привода затвора для желаемого значения di / dt
Применение среднего значения GFS к уравнению 1 приводит к напряжению управления затвором Vdrive = 10 В, требуемому di / dt = 600 A / мкс, типичным значениям FCP11N60 VGS (avg) = 6 В и Ciss = 1200 пФ; Импеданс привода затвора составляет 37 Ом.Поскольку переходное значение GFS представляет собой диагональную линию на графике на Рисунке 3, изменение происходит во время Eon, то есть di / dt также изменяется. Экспоненциально затухающий ток возбуждения затвора Vdrive и падающий Ciss также входят в формулу как функция VGS, демонстрируя общий эффект с неожиданным линейным ростом тока.
Аналогичным образом, аналогичные расчеты сопротивления включения затвора могут быть выполнены для IGBT. VGE (avg) и GFS могут быть определены характеристиками переключения IGBT, а значения CIES при VGE (avg) используются вместо Ciss.Расчетное сопротивление привода затвора включения IGBT составляет 100 Ом, что выше, чем предыдущие 37 Ом, что указывает на то, что IGBT GFS выше CIES ниже. Ключевым моментом здесь является то, что для переключения с MOSFET на IGBT необходимо настроить схему управления затвором.
VI Подробное объяснение потерь проводимости
БТИЗ обычно имеют меньшие потери проводимости, чем полевые МОП-транзисторы на 600 В с таким же размером микросхемы по сравнению с устройствами, рассчитанными на 600 В. Такие сравнения следует проводить, когда четко измеряются плотности тока коллектора и стока и в худшем случае рабочая температура перехода.Например, IGBT FGP20N6S2 SMPS2 и SuperFET FCP11N60 имеют значение RθJC, равное 1 ° C / Вт. На рисунке 4 показаны зависимости потерь проводимости от постоянного тока при температуре перехода 125 ° C. График показывает, что потери проводимости МОП-транзистор больше при постоянном токе более 2,92 А.
Рисунок 4: Потери проводимости при работе на постоянном токе и Рисунок 5: Потери проводимости в цепи повышения коэффициента мощности CCM
Однако потери проводимости при постоянном токе на Рисунке 4 менее подходят для большинства приложений.Между тем, на рисунке 5 показано сравнение потерь проводимости в CCM (режим непрерывного тока), в цепи повышающего PFC, температуре перехода 125 ° C и рабочих режимах при входном напряжении переменного тока 85 В и выходном напряжении постоянного тока 400 В постоянного тока. На рисунке точка пересечения кривой MOSFET-IGBT составляет 2,65 А RMS. Для схем PFC полевые МОП-транзисторы имеют более высокие потери проводимости, когда входной переменный ток превышает 2,65 А. Входной ток переменного тока PFC 2,65 А равен 2,29 А RMS, рассчитанному по формуле 2 для полевого МОП-транзистора.Рассчитываются потери проводимости полевого МОП-транзистора, I2R, ток, определяемый уравнением 2, и RDS (вкл.) Полевого МОП-транзистора при 125 ° C. Принимая во внимание RDS (вкл.) Для изменения тока стока, потери проводимости могут быть дополнительно уточнены, как показано на рисунке 6.
Рисунок 6: FCP11N60 (MOSFET): RDS (включено) с изменениями IDRAIN и VGE
Статья под названием «Как включить RDS (on) Power MOSFET в зависимость переходных значений тока стока от потерь проводимости в высокочастотных трехфазных инверторах с ШИМ» в IEEE описывает, как определить влияние тока стока на потери проводимости.Как идентификатор функции, изменения в RDS (on) мало влияют на большинство топологий SMPS. Например, в схеме PFC, когда ID пикового тока полевого МОП-транзистора FCP11N60 составляет 11 А — в два раза больше 5,5 А (спецификация RDS (on)), эффективное значение RDS (on) и потери проводимости увеличиваются на 5%.
В топологии с сильным пульсирующим током, где полевые МОП-транзисторы проводят очень малые рабочие циклы, следует учитывать характеристики, показанные на рисунке 6. Если полевой МОП-транзистор FCP11N60 работает в цепи с током стока, равным 20 А (т. Е. 5.5A RMS) при рабочем цикле 7,5%, эффективное значение RDS (включено) будет менее 5,5 A (испытательный ток в таблице данных) 0,32 Ом, большой 25%.
Среднеквадратичный ток по уравнению 2 в цепи PFC CCM
В уравнении 2 Iacrms — это действующий входной ток цепи PFC; Vac — действующее значение входного напряжения цепи PFC; Vout — выходное напряжение постоянного тока.
В практических приложениях вычисление потерь проводимости IGBT в аналогичных схемах PFC будет более сложным, поскольку каждый цикл переключения выполняется на разных ИС.VCE (sat) IGBT не может быть представлен одним импедансом. Более простой и понятный метод — представить его в виде резистора RFCE, включенного последовательно с фиксированным напряжением VFCE, VCE (ICE) = ICE × RFCE + VFCE. Затем потери проводимости могут быть рассчитаны как произведение среднего тока коллектора и VFCE, плюс квадрат среднеквадратичного значения тока коллектора, умноженного на импеданс RFCE.
В примере на рис. 5 рассматриваются только потери проводимости в цепи CCM PFC, которые предполагается менее 15 Вт для расчетной цели с наихудшим случаем проводимости.Взяв в качестве примера полевой МОП-транзистор FCP11N60, эта схема ограничена 5,8 А, а IGBT FGP20N6S2 может работать при входном токе переменного тока 9,8 А. Он проводит более 70% мощности MOSFET. Хотя IGBT имеют низкие потери проводимости, большинство IGBT на 600 В являются устройствами PT (Punch Through). Устройства PT имеют характеристики NTC (отрицательный температурный коэффициент) и не могут шунтировать параллельно. Возможно, эти устройства можно использовать параллельно с ограниченным успехом путем согласования устройств VCE (sat), VGE (TH) (пороговое напряжение срабатывания затвора) и механических корпусов, чтобы температура микросхем IGBT могла поддерживаться в постоянном соответствии.Напротив, MOSFET имеет PTC (положительный температурный коэффициент), который обеспечивает хорошее шунтирование тока.
VII Потери при выключении
В схемах с жесткой коммутацией и индуктивным ограничением полевые МОП-транзисторы имеют гораздо более низкие потери при выключении, чем IGBT, из-за остаточного тока IGBT, который связан с удалением неосновных носителей заряда. PNP BJT на рисунке 1. На рисунке 7 показана функция Eoff тока коллектора ICE и температуры перехода Tj, кривые которой представлены в большинстве таблиц данных IGBT.Эти кривые основаны на замкнутых индуктивных цепях, имеют одинаковое испытательное напряжение и содержат потери энергии остаточного тока.
Рисунок 7: IGBT Eoff с ICE и изменениями Tj
На рис. 2 показана типичная испытательная схема для измерения Eoff IGBT. Его испытательное напряжение, VDD на рисунке 2, зависит от BVCES для разных производителей и отдельных устройств. VDD в этом тестовом состоянии следует учитывать при сравнении устройств, поскольку тестирование и работа при более низком напряжении фиксации VDD приведет к снижению энергопотребления Eoff.
Снижение сопротивления срабатывания затвора мало влияет на снижение потерь Eoff IGBT. Как показано на рисунке 1, все еще существует задержка времени хранения td (off) I в неосновных несущих IGBT BJT, когда эквивалентный многочастотный MOSFET выключен. Однако уменьшение импеданса возбуждения Eoff снизит риск инжекции тока в контур возбуждения затвора из-за емкости CRES и dv / dt Миллера при выключенном VCE, предотвращая смещение устройства в проводящее состояние, что приводит к множественному Eoff- генерирование коммутационных действий.
ТопологииZVS и ZCS снижают потери при отключении полевых МОП-транзисторов и IGBT. Однако преимущества ZVS не так велики в IGBT. Поскольку остаточный пусковой ток Eoff индуцируется, когда напряжение коллектора повышается до потенциала, позволяющего рассеять избыточный накопленный заряд. Топология ZCS может повысить максимальную производительность IGBT Eoff. Правильная последовательность управления затвором позволяет не очищать сигнал затвора IGBT до того, как ток второго коллектора пересечет ноль, что значительно снижает Eoff ZCS IGBT.
Энергопотребление Eoff полевого МОП-транзистора является функцией его емкости Миллера Crss, скорости возбуждения затвора, импеданса затвора от источника и паразитной индуктивности в цепи цепи питания источника. Паразитная индуктивность Lx схемы (рис. 8) создает потенциал, который увеличивает потери при выключении, ограничивая текущее падение скорости. При отключении скорость падения тока di / dt определяется Lx и VGS (th). Если Lx = 5 нГн, VGS (th) = 4 В, максимальная скорость падения тока составляет VGS (th) / Lx = 800 A / мкс.
Рисунок 8: Схема управления затвором в типичных приложениях с жесткой коммутацией
VIII Как выбрать MOSFET и IGBT
MOSFET и IGBT быстро заменяют подавляющее большинство старых твердотельных и механических устройств. Это движение, похоже, тоже не замедлится в ближайшее время, особенно с развитием качественного материала карбида кремния (SiC). Силовые устройства SiC демонстрируют такие преимущества разработчиков, как меньшие потери, меньший размер и повышенная эффективность.Подобные инновации будут и дальше расширять пределы возможностей MOSFET и IGBT в приложениях с более высоким напряжением и большей мощностью. В результате компромиссы и совпадения, вероятно, продолжатся во многих приложениях. В этом случае тщательный анализ самого устройства, пожалуй, является наиболее логичным решением, когда возникает задача выбора транзистора для вашего приложения SMPS.
Комплексных решений при выборе силовых коммутационных аппаратов не существует. Топология схем, рабочие частоты, температура окружающей среды и физические размеры — все это играет важную роль в выборе наилучшего.В приложениях ZVS и ZCS с минимальными потерями Eon полевые МОП-транзисторы могут работать на более высоких частотах из-за их более высоких скоростей переключения и меньших потерь переключения. Поведение паразитных диодов MOSFET при восстановлении может быть недостатком для приложений с жестким переключением. Напротив, превосходные диоды с мягким восстановлением совместимы с высокоскоростными SMPS-устройствами, поскольку диоды в корпусе IGBT предназначены для конкретных приложений.
Закрытие : Нет существенной разницы между MOSFE и IGBT.Люди часто задают вопрос, «хорош ли MOSFET или IGBT хорош», сам по себе является ошибкой. Почему мы иногда используем MOSFET, а иногда используем IGBT вместо MOSFET? Нельзя просто описать хорошие и плохие стороны, чтобы различать и определять . Для рассмотрения этого вопроса необходимо использовать диалектические методы.
Рекомендация книги
В этой книге в основном говорится о MOSFET. ИС драйвера IGBT и приложение.
— БЕН ШЭ.И МИН (Автор)
Разработанный для односеместрового курса для младших, старших курсов или выпускников, MOSFET Theory and Design представляет собой четкое и углубленное рассмотрение физического анализа и принципов проектирования MOSFET.Сосредоточив внимание исключительно на MOSFET, этот небольшой том признает доминирование этого устройства в современной технологии микроэлектроники, а также предоставляет студентам эффективный текст, свободный от дополнительных предметов. MOSFET Theory and Design предлагает практический подход к обучению с использованием аналитических, компьютерных и дизайнерских задач. Он включает в себя дополнительные педагогические пособия, такие как краткое изложение книги, вопросы для повторения, в которых подчеркиваются существенные моменты, упражнения в тексте с соответствующими решениями и обширную библиографию.
— Теория и конструкция MOSFET
Устройство IGBT зарекомендовало себя как очень важный силовой полупроводник, обеспечивающий основу для приводов электродвигателей с регулируемой скоростью (используемых в системах кондиционирования воздуха и охлаждения, а также в железнодорожных локомотивах), электронных систем зажигания для бензиновых автомобилей и энергосберегающих компактных люминесцентных ламп. Недавние применения включают плазменные дисплеи (телевизоры с плоским экраном) и системы передачи электроэнергии, альтернативные энергетические системы и накопители энергии.Эта книга — первая доступная книга, которая охватывает приложения IGBT и предоставляет важную информацию, необходимую разработчикам приложений для разработки новых продуктов с использованием этого устройства в таких секторах, как потребительская, промышленная, осветительная, транспортная, медицинская и возобновляемые источники энергии.
— Б. Джаянт Балига (Автор)
Соответствующая информация о «Анализ различий между MOSFET и IGBT»
О статье «Анализ различий между MOSFET и IGBT». Если у вас есть лучшие идеи, не стесняйтесь писать свои мысли в следующей области комментариев.Вы также можете найти больше статей об электронных полупроводниках через поисковую систему Google или обратиться к следующим связанным статьям.
Planet Analog — IGBT лучше, чем MOSFET?
Я выполнил свою долю проектов питания, как импульсных источников питания, так и контроллеров двигателей с Н-мостом. Еще в 1970-х и 1980-х годах в моих проектах использовались биполярные силовые транзисторы NPN. Мы редко использовали устройства PNP, потому что они обычно стоят дороже и не были доступны с такими же высокими рейтингами, как их аналоги NPN (при прочих равных).
Мы также сторонились транзисторов Дарлингтона. Они имеют усиление от высокого до очень высокого, но их напряжение насыщения также велико, что значительно увеличивает мощность, рассеиваемую внутри устройства.
NPN транзистор Дарлингтона
Поскольку коллектор входного транзистора соединяется с коллектором выходного транзистора, как только выходной транзистор начинает включаться, он отбирает ток возбуждения (или лишает источник напряжения, если хотите) входного транзистора.Результатом является насыщение составного устройства примерно на 1 вольт. При высоких токах коллектора рассеиваемая в устройстве мощность заставляет его нагреваться.
С 1980-х годов и по настоящее время предпочтительным транзистором был N-канальный MOSFET. Как и в случае с биполярными устройствами, полевые транзисторы с каналом P не были доступны с такой высокой номинальной мощностью и были более дорогими. С полевыми транзисторами чрезвычайно высокий входной импеданс упрощает управление затвором . Емкость затвор-исток несколько сводит на нет это преимущество, особенно на высоких частотах переключения.
Я никогда не использовал биполярные транзисторы с изолированным затвором (IGBT), отчасти потому, что я никогда не понимал их полностью. Изначально я думал о них как об устройствах Дарлингтона с N-канальным полевым транзистором, заменяющим входной биполярный транзистор. В результате получится устройство с чрезвычайно высоким входным импедансом и высоким общим коэффициентом усиления, но, конечно, все равно будет высокое напряжение насыщения и соответствующая большая рассеиваемая мощность.
В последнее время я вижу все больше пресс-релизов, в которых говорится об устройствах IGBT, поэтому я решил поближе взглянуть на то, что это за устройства на самом деле.Беглый взгляд на Википедию показывает, что я был прав лишь частично в отношении своих предположений о внутренней работе.
Функциональный эквивалент IGBT
(Источник: Википедия)
Ага! Фактически он использует N-канальный полевой транзистор в качестве устройства ввода, но биполярное устройство является устройством PNP. Теперь он становится намного более эффективным, и устройство может иметь очень высокое напряжение пробоя. Включите полевой транзистор всего на несколько вольт, и вы сильно включите PNP-транзистор. Есть тот паразитный NPN-транзистор; в сочетании с PNP это делает биполярную часть похожей на SCR.Фактически, ранние IGBT-устройства страдали от защелкивания: иногда, включив их, вы не могли выключить их, если не отключили ток коллектора (отключили основной источник питания). Эта проблема была решена с помощью современных устройств.
Кстати, вы увидите разные символы для IGBT; этот полураспространенный:
Часто используемый символ для IGBT
(Источник: Википедия)
Обратите внимание, что верхний вывод называется коллектором, но он подключается к эмиттеру PNP.Это просто для того, чтобы всем было проще понять, как он используется, а не то, что происходит внутри.
Эти устройства не подходят для всех приложений. У них более низкое прямое падение напряжения, чем у обычных полевых МОП-транзисторов, если сравнивать их с сопоставимыми высоковольтными и сильноточными устройствами (вплоть до киловольт и сотен ампер). При более умеренных уровнях тока лучше использовать обычные полевые транзисторы. А если вам нужны высокие скорости переключения для скоростей ШИМ — в диапазоне сотен кГц или МГц — снова используйте обычные полевые транзисторы.
Сообщите мне, использовали ли вы эти устройства и насколько хорошо они работали в вашем приложении.
Разница между IGBT и MOSFET
Биполярные транзисторы были единственным мощным транзистором, который использовался до тех пор, пока в начале 1970-х не появились очень эффективные полевые МОП-транзисторы. Биполярные транзисторы претерпели существенные улучшения в своих электрических характеристиках с момента своего появления в конце 1947 года и до сих пор широко используются в электронных схемах. Биполярные транзисторы имеют относительно медленное выключение и имеют отрицательный температурный коэффициент, что может привести к вторичному пробою.Однако полевые МОП-транзисторы — это устройства, которые управляются напряжением, а не током. У них есть положительный температурный коэффициент сопротивления, который останавливает тепловой разгон и, как следствие, не происходит вторичного пробоя. Затем в конце 80-х годов прошлого века на сцену вышли IGBT. IGBT в основном представляет собой нечто среднее между биполярными транзисторами и MOSFET, а также управляется напряжением, как и MOSFET. В этой статье освещаются некоторые ключевые моменты, сравнивающие два устройства.
Что такое полевой МОП-транзистор?
MOSFET, сокращение от «Metal Oxide Semiconductor Field Effect Transistor», — это особый тип полевого транзистора, широко используемый в очень больших интегральных схемах благодаря своей сложной конструкции и высокому входному сопротивлению.Это четырехконтактный полупроводниковый прибор, который управляет как аналоговыми, так и цифровыми сигналами. Затвор расположен между истоком и стоком и изолирован тонким слоем оксида металла, который предотвращает протекание тока между затвором и каналом. Сейчас эта технология используется во всех типах полупроводниковых устройств для усиления слабых сигналов.
Что такое IGBT?
IGBT, что означает «биполярный транзистор с изолированным затвором», представляет собой трехконтактное полупроводниковое устройство, которое сочетает в себе пропускную способность биполярного транзистора с легкостью управления, как у полевого МОП-транзистора.Это относительно новое устройство в силовой электронике, которое обычно используется в качестве электронного переключателя в широком диапазоне приложений, от приложений средней до сверхвысокой мощности, таких как импульсные источники питания (SMPS). Его структура почти идентична структуре MOSFET, за исключением дополнительной p-подложки под n-подложкой.
Разница между IGBT и MOSFET
Базовый IGBT и MOSFET
IGBT означает биполярный транзистор с изолированным затвором, тогда как MOSFET — это сокращение от Metal-Oxide Semiconductor Field Effect Transistor.Хотя оба являются полупроводниковыми устройствами с регулируемым напряжением, которые лучше всего работают в импульсных источниках питания (SMPS), IGBT сочетают в себе возможности обработки больших токов биполярных транзисторов с простотой управления MOSFET. IGBT — это ограничители тока, сочетающие в себе преимущества BJT и MOSFET для использования в цепях питания и управления двигателями. MOSFET — это особый тип полевого транзистора, в котором приложенное напряжение определяет проводимость устройства.
Принцип работы IGBT и MOSFET
IGBT — это, по сути, полевой МОП-транзистор, который управляет силовым транзистором с биполярным переходом, причем оба транзистора интегрированы в один кусок кремния, тогда как полевой МОП-транзистор является наиболее распространенным полевым транзистором с изолированным затвором, который чаще всего изготавливается путем контролируемого окисления кремния.МОП-транзистор обычно работает путем электронного изменения ширины канала с помощью напряжения на электроде, называемом затвором, который расположен между истоком и стоком и изолирован тонким слоем оксида кремния. МОП-транзистор может работать двумя способами: режим истощения и режим улучшения.
Входное сопротивление IGBT и MOSFET
IGBT — это биполярное устройство, управляемое напряжением, с высоким входным импедансом и большой способностью выдерживать ток, как у биполярного транзистора.Их можно легко контролировать по сравнению с устройствами с текущим управлением в сильноточных приложениях. МОП-транзисторы практически не требуют входного тока для управления током нагрузки, что делает их более резистивными на выводе затвора благодаря изоляционному слою между затвором и каналом. Слой изготовлен из оксида кремния, который является одним из лучших используемых изоляторов. Он эффективно блокирует приложенное напряжение, за исключением небольшого тока утечки.
Сопротивление урону
MOSFET более восприимчивы к электростатическому разряду (ESD), так как высокий входной импеданс технологии MOS в MOSFET не позволяет заряду рассеиваться более контролируемым образом.Дополнительный изолятор из оксида кремния снижает емкость затвора, что делает его уязвимым для очень высоких всплесков напряжения, неизбежно повреждающих внутренние компоненты. МОП-транзисторы очень чувствительны к электростатическим разрядам. БТИЗ третьего поколения сочетают в себе характеристики управления напряжением полевого МОП-транзистора с низким сопротивлением в открытом состоянии биполярного транзистора, что делает их чрезвычайно устойчивыми к перегрузкам и скачкам напряжения.
Применение IGBT и MOSFET
MOSFET-транзисторы широко используются для переключения и усиления электронных сигналов в электронных устройствах, как правило, для приложений с высоким уровнем шума.Чаще всего полевые МОП-транзисторы применяются в импульсных источниках питания, к тому же они могут использоваться в усилителях класса D. Они являются наиболее распространенными полевыми транзисторами и могут использоваться как в аналоговых, так и в цифровых схемах. IGBT, с другой стороны, используются в приложениях средней и сверхвысокой мощности, таких как импульсный источник питания, индукционный нагрев и управление тяговым двигателем. Он используется как жизненно важный компонент в современной бытовой технике, такой как электромобили, балласты для ламп и частотно-регулируемые приводы.
IGBT vs.MOSFET: Сравнительная таблица
Обзор IGBT Vs. МОП-транзистор
Хотя и IGBT, и MOSFET являются полупроводниковыми устройствами с регулируемым напряжением, которые в основном используются для усиления слабых сигналов, IGBT сочетают в себе низкое сопротивление биполярного транзистора с характеристиками управления напряжением MOSFET. С увеличением числа вариантов выбора между двумя устройствами становится все труднее выбрать лучшее устройство на основе только их приложений.MOSFET — это четырехконтактное полупроводниковое устройство, тогда как IGBT — это трехконтактное устройство, которое представляет собой нечто среднее между биполярным транзистором и MOSFET, что делает их чрезвычайно устойчивыми к электростатическому разряду и перегрузкам.
Сагар Хиллар — плодовитый автор контента / статей / блогов, работающий старшим разработчиком / писателем контента в известной фирме по обслуживанию клиентов, базирующейся в Индии. У него есть желание исследовать самые разные темы и разрабатывать высококачественный контент, чтобы его можно было лучше всего читать.Благодаря его страсти к писательству, он имеет более 7 лет профессионального опыта в написании и редактировании услуг на самых разных печатных и электронных платформах.Вне своей профессиональной жизни Сагар любит общаться с людьми из разных культур и происхождения. Можно сказать, что он любопытен по натуре. Он считает, что каждый — это опыт обучения, и это приносит определенное волнение, своего рода любопытство, чтобы продолжать работать. Поначалу это может показаться глупым, но через некоторое время это расслабляет вас и облегчает начало разговора с совершенно незнакомыми людьми — вот что он сказал.»
Последние сообщения от Sagar Khillar (посмотреть все): Если вам понравилась эта статья или наш сайт. Пожалуйста, расскажите об этом. Поделитесь им с друзьями / семьей.
Укажите
Сагар Хиллар. «Разница между IGBT и MOSFET». DifferenceBetween.net. 7 июня 2018.
IGBT (биполярный транзистор с изолированным затвором) 1 Различия между MOSFET и IGBT
Рекомендации по применению AN-983
Замечания по применению AN-983 Характеристики IGBT Содержание 1.Как IGBT дополняет силовой полевой МОП-транзистор … 2 Стр. 2. Кремниевая структура и эквивалентная схема … 2 3. Характеристики проводимости … 4
ПодробнееЗАЖИГАНИЕ АВТОМОБИЛЯ С IGBTS
ЗАМЕЧАНИЕ ПО ПРИМЕНЕНИЮ ЗАЖИГАНИЕ АВТОМОБИЛЯ С IGBT от M. Melito ABSTRACT IGBT используются в различных коммутационных приложениях благодаря своим привлекательным характеристикам, в частности, их пиковому току,
ПодробнееМОП-транзисторы как переключатели
МОП-транзисторы как переключатели G (затвор) НМО-транзистор: закрыт (проводящий), когда затвор = 1 (В DD) D (сток) S (исток) Оен (непроводящий), когда затвор = 0 (земля, 0 В) G МОП-транзистор: Закрытые (проводящие)
Дополнительная информация5SNA 3600E170300 Модуль HiPak IGBT
Технические данные, док.№ 5SYA 44-6 2-24 5SNA 36E73 HiPak IGBT Module VCE = 7 V IC = 36 A Прочный SPT с ультранизкими потерями + набор микросхем Плавная коммутация SPT + набор микросхем для хорошей ЭМС Базовая плата AlSiC для циклического включения большой мощности
Дополнительная информацияХарактеристики. Символ JEDEC TO-220AB
Технический паспорт Июнь 1999 г. Номер файла 2253.2 3A, 5 В, 0,4 Ом, N-канальный силовой МОП-транзистор Это силовой полевой транзистор с кремниевым затвором с N-канальным режимом расширения, разработанный для таких приложений, как коммутация
Дополнительная информацияПОЛОВИННАЯ И ПОЛНОВолновая РЕКТИФИКАЦИЯ
ПОЛУПРОВОДНАЯ И ПОЛНОПРОВОДНАЯ РЕКТИФИКАЦИЯ Цели: ПОЛОВИННАЯ И ПОЛНАЯ РЕКТИФИКАЦИЯ Для распознавания полуволнового выпрямленного синусоидального напряжения.Чтобы понять термин «среднее значение» как связанный с выпрямленной формой волны.
Дополнительная информацияРекомендации по применению AN-940
Замечания по применению AN-940 Как МОП-транзисторы с P-каналом могут упростить схему Содержание Стр. 1. Основные характеристики силовых МОП-транзисторов с P-каналом HEXFET … 1 2. Заземленные нагрузки … 1 3. Переключение на тотемных полюсах
Дополнительная информацияРекомендации по применению AN-1070
Замечания по применению AN-1070 Зависимость характеристик усилителя звука класса D от параметров полевого МОП-транзистора Хорхе Серезо, International Rectifier Содержание страницы Аннотация… 2 Введение … 2 Ключевой полевой МОП-транзистор
Дополнительная информацияIRGP4068DPbF IRGP4068D-EPbF
БИПОЛЯРНЫЙ ТРАНЗИСТОР С ИЗОЛИРОВАННЫМ ЗАДВИЖЕНИЕМ С УЛЬТРА-НИЗКИМ VF-ДИОДОМ ДЛЯ ИНДУКЦИОННОГО НАГРЕВА И ПЛАВНОГО ПЕРЕКЛЮЧЕНИЯ Дополнительная информация
Оптрон с приводом затвора на IGBT / MOSFET
ISHY SMIONDUTORS www.vishay.com Оптопары и твердотельные реле IGBT / MOSFT Gate Drive Оптопара ВВЕДЕНИЕ В IGBT Биполярный транзистор с изолированным затвором (IGBT представляет собой нечто среднее между MOSFT (оксид металла
) Дополнительная информацияLCDA12C-8 и LCDA15C-8
ВРАЩАЮЩИЕ СТЕРЖНИ Описание LCDAxxC-8 был специально разработан для защиты чувствительных компонентов, подключенных к линиям передачи данных и передачи данных, от перенапряжения, вызванного электростатическим разрядом
Дополнительная информацияSTGB10NB37LZ STGP10NB37LZ
STGB10NB37LZ STGP10NB37LZ 10 A — 410 В IGBT с внутренним ограничением Характеристики Низкое пороговое напряжение Низкое падение напряжения Низкий заряд затвора TAB TAB Высокая токовая характеристика Функция фиксации высокого напряжения Приложения
Дополнительная информацияУказания по применению AN-11001
Приложение A-00 Редакция: Дата выпуска: отредактировал: 04 0-09-03 Ingo Staudt Ключевые слова: 3L, C, TC, C, MC, многоуровневый, расчет потерь, SemiSel 3L C и топология TC… Разница L 3L … Переключение
Дополнительная информацияУказания по применению AN-1095
Примечание по применению AN-1095 Конструкция выходного фильтра инвертора для приводов двигателей с силовыми модулями IRAMS Cesare Bocchiola Содержание Стр. Раздел 1: Введение … 2 Раздел 2: Конструкция выходного фильтра
Дополнительная информацияBUZ11. 30 А, 50 В, 0,040 Ом, N-канальный силовой полевой МОП-транзистор.Характеристики. [/ Заголовок (BUZ1 1) / Тема. (30 А, 50 В, 0,040 Ом, канал N. Информация для заказа
Технические данные Июнь 1999 Номер файла 2253.2 [/ Название (BUZ1 1) / Тема (3A, 5V, 0,4 Ом, N-Channel Power MOS- FET) / Автор () / Ключевые слова (Intersil Corporation, N-Channel Power MOS- FET, TO- 22AB) / Создатель
Дополнительная информацияГлава 2 Требования к приложению
Глава 2 Требования к приложениям Материал, представленный в этом сценарии, охватывает низковольтные приложения, начиная от портативной электроники с батарейным питанием и заканчивая преобразователями POL (точка нагрузки), Интернет
Дополнительная информацияХарактеристики и усилители BJT
Характеристики и усилители БЮТ Мэтью Беклер beck0778 @ umn.edu EE2002 Lab Section 003 2 апреля 2006 г. Резюме Как основной компонент в конструкции усилителя, свойства биполярного переходного транзистора
Дополнительная информацияУчебное пособие по Power MOSFET
Учебное пособие по силовому полевому МОП-транзистору Джонатан Додж, П. Менеджер по разработке приложений Advanced Power Technology 405 S.W. Columbia Street Bend, OR 97702 Введение Силовые полевые МОП-транзисторы хорошо известны своей превосходной коммутацией
Дополнительная информацияМОП-транзистор
MOSFET-транзистор Основным активным компонентом всех кремниевых микросхем является MOSFET-металлооксидный полупроводниковый полевой транзистор. Условное обозначение G Затвор S Источник D Сток Напряжение на затворе управляет
Дополнительная информацияSMS05C через SMS24C
ВРАЩАЮЩИЕ СТЕРЖНИ Описание Матрицы TS серии SMS предназначены для защиты чувствительной электроники от повреждений или защелкивания из-за электростатического разряда и других переходных процессов, вызванных напряжением.Каждое устройство будет защищено
Дополнительная информацияRFG70N06, RFP70N06, RF1S70N06, RF1S70N06SM
А М А А Декабрь 995 г. ПОЛУПРОВОДНИК RFG7N6, RFP7N6, RFS7N6, RFS7N6SM 7A, 6 В, лавинный режим, N-канальный силовой МОП-транзистор Характеристики 7A, 6 В r DS (вкл.) = 0,4 Ом PSPICE, модель
с температурной компенсацией Дополнительная информацияОсновы биполярных переходных транзисторов
Кеннет А.Kuhn 29 сентября 2001 г., ред. 1 Введение Транзистор с биполярным переходом (BJT) — это трехслойный полупроводниковый прибор с конструкцией NPN или PNP. Обе конструкции имеют одинаковые
Дополнительная информацияГлава 4. LLC Резонансный преобразователь.
Глава 4 LLC Резонансный преобразователь 4.1 Введение В предыдущих главах обсуждались тенденции и технические проблемы для внешнего преобразователя постоянного тока в постоянный. Высокая удельная мощность, высокая эффективность и мощность
Дополнительная информацияМодели транзисторов.ампель
Модели транзисторов Обзор основ транзисторов Простая модель усилителя тока Пример транзисторного переключателя Пример усилителя с общим эмиттером Транзистор как преобразователь — модель Эберс-Молла Прочее
Дополнительная информацияСиловой транзистор CoolMOS TM
Характеристики силового транзистора CoolMOS TM Новая революционная технология высокого напряжения. Внутренний диод с быстрым восстановлением в корпусе. Чрезвычайно низкий заряд обратного восстановления. Сверхнизкий заряд затвора. Дополнительная информация
IRF640, RF1S640, RF1S640SM
IRF64, RFS64, RFS64SM Технические данные 22 января 8A, 2V ,.8 Ом, N-канальные силовые полевые МОП-транзисторы. Это силовые полевые транзисторы с кремниевым затвором с N-канальным режимом расширения. Это усовершенствованные силовые полевые МОП-транзисторы,
Дополнительная информация Учебное пособие поIGBT. Введение. Как выбрать IGBT. Обзор IGBT. Примечание по применению APT0201 Ред. B 1 июля, Джон Хесс, вице-президент по маркетингу
1 Указание по применению APT0201 Ред.B 1 июля 2002 г. Джонатан Додж, П.Е. Учебное пособие для старшего инженера по IGBT Advanced Power Technology 405 S.W. Columbia Street Bend, штат Орегон, Джон Хесс, вице-президент по маркетингу. Введение Благодаря сочетанию легко управляемого затвора MOS и низких потерь проводимости IGBT быстро вытеснили силовые биполярные транзисторы в качестве предпочтительного устройства для приложений с высоким током и высоким напряжением. Баланс между скоростью переключения, потерями проводимости и прочностью в настоящее время постоянно настраивается так, что IGBT вторгаются в высокочастотную и высокоэффективную область силовых MOSFET.Фактически, отраслевая тенденция заключается в том, что IGBT заменяют силовые MOSFET, за исключением приложений с очень низким током. Чтобы помочь понять компромиссы и помочь разработчикам схем в выборе и применении устройства IGBT, в этой заметке по применению представлен относительно безболезненный обзор технологии IGBT и пошаговое руководство по информации таблицы данных IGBT Advanced Power Technology. Как выбрать IGBT Этот раздел намеренно помещен перед техническим дискурсом. Ответы на следующий набор животрепещущих вопросов помогут определить, какой IGBT подходит для конкретного приложения.Различия между непробиваемыми (NPT) и сквозными (PT) устройствами, а также термины и графики будут объяснены позже. 1. Какое рабочее напряжение? Максимальное напряжение, которое должен блокировать IGBT, не должно превышать 80% от номинального значения V CES. 2. Переключается он программно или жестко? Устройство PT лучше подходит для плавного переключения из-за пониженного хвостового тока, однако устройство NPT также будет работать. 3. Какой ток будет проходить через устройство? Первые два числа в номере детали дают приблизительное представление о допустимом токе.Для приложений с жестким переключением график зависимости полезной частоты от тока помогает определить, подходит ли устройство для данного приложения. Следует учитывать различия между условиями тестирования в таблице данных и приложением, а пример того, как это сделать, будет приведен позже. Для приложений с плавным переключением в качестве отправной точки можно использовать рейтинг I C2. 4. Какая желаемая скорость переключения? Если ответ выше, тем лучше, то лучшим выбором будет устройство PT. Опять же, график зависимости полезной частоты от тока может помочь ответить на этот вопрос для приложений с жестким переключением.5. Требуется ли устойчивость к короткому замыканию? Для таких приложений, как моторные приводы, ответ — да, и частота коммутации также имеет тенденцию быть относительно низкой. Потребуется устройство NPT. Импульсные источники питания часто не требуют защиты от короткого замыкания. Обзор IGBT n + n + p Область тела n- Область дрейфа n + Буферный слой (PT IGBT) p + Подложка (вводящий слой) Коллектор-эмиттер Затвор Рисунок 1 N-канальное сечение IGBT Структура N-канального MOSFET 1
2 N-канальный IGBT — это, по сути, N-канальный силовой полевой МОП-транзистор, построенный на подложке p-типа, как показано на общем поперечном сечении IGBT на рисунке 1.(PT IGBT имеет дополнительный слой n +, что будет объяснено ниже.) Следовательно, работа IGBT очень похожа на силовой MOSFET. Положительное напряжение, приложенное от эмиттера к выводам затвора, заставляет электроны притягиваться к выводу затвора в области тела. Если напряжение затвор-эмиттер равно или превышает так называемое пороговое напряжение, достаточно электронов притягивается к затвору, чтобы сформировать проводящий канал через область тела, позволяя току течь от коллектора к эмиттеру.(Точнее, он позволяет электронам течь от эмиттера к коллектору.) Этот поток электронов притягивает положительные ионы или дырки от подложки p-типа в область дрейфа к эмиттеру. Это приводит к паре упрощенных эквивалентных схем для IGBT, как показано на рисунке 2. Затвор-коллектор-эмиттер затвор-коллектор-эмиттер Рисунок 2. Упрощенные эквивалентные схемы на IGBT Первая схема показывает N-канальный силовой MOSFET, управляющий биполярным транзистором PNP с широкой базой в транзисторе Дарлингтона. конфигурация.Вторая схема просто показывает диод, включенный последовательно со стоком N-канального силового MOSFET. На первый взгляд может показаться, что напряжение в открытом состоянии на IGBT будет на один диод больше, чем для N-канального силового MOSFET самого по себе. Это правда, что напряжение в открытом состоянии на IGBT всегда равно как минимум одному падению на диоде. Однако по сравнению с силовым MOSFET того же размера, работающим при той же температуре и токе, IGBT может иметь значительно более низкое напряжение в состоянии.Причина этого в том, что MOSFET — это только устройство-носитель большинства. Другими словами, в N-канальном MOSFET текут только электроны. Как упоминалось ранее, подложка p-типа в N-канальном IGBT вводит дырки в область дрейфа. Следовательно, ток в IGBT состоит как из электронов, так и из дырок. Такая инжекция дырок (неосновных носителей заряда) значительно снижает эффективное сопротивление току в области дрейфа. Иначе говоря, инжекция дырок значительно увеличивает проводимость, или же проводимость модулируется.Результирующее снижение напряжения в открытом состоянии является основным преимуществом IGBT перед силовыми MOSFET. Конечно, ничего не дается бесплатно, и цена за более низкое напряжение во включенном состоянии — более низкая скорость переключения, особенно при выключении. Причина этого заключается в том, что во время выключения поток электронов может быть остановлен довольно резко, как и в силовом MOSFET, путем уменьшения напряжения затвор-эмиттер ниже порогового напряжения. Однако дырки остаются в области дрейфа, и нет никакого способа удалить их, кроме градиента напряжения и рекомбинации.IGBT показывает хвостовой ток во время выключения до тех пор, пока все отверстия не будут удалены или повторно объединены. Скорость рекомбинации можно контролировать, что и является целью буферного слоя n +, показанного на рисунке 1. Этот буферный слой быстро поглощает захваченные дыры во время выключения. Не все IGBT имеют буферный слой n +; те, которые есть, называются сквозными (PT), те, которые не работают, называются непробиваемыми (NPT). PT IGBT иногда называют асимметричным, а NPT — симметричным. Другая цена за более низкое напряжение во включенном состоянии — это возможность фиксации, если IGBT работает за пределами номинальных значений, указанных в таблице данных.Latchup — это режим отказа, при котором IGBT больше не может быть отключен затвором. Latchup может быть вызван неправильным использованием любого IGBT. Таким образом, механизм отказа защелкивания в IGBT требует некоторого объяснения. Основная структура IGBT напоминает тиристор, а именно серию переходов PNPN. Это можно объяснить, проанализировав более подробную модель эквивалентной схемы для IGBT, показанную на рисунке 3. Сопротивление области дрейфа затвора Паразитный NPN-коллектор Эмиттер Паразитный тиристор Сопротивление распространения области корпуса Рисунок 3 Модель IGBT, показывающая паразитный тиристор Паразитный биполярный транзистор NPN существует во всех N — канальные силовые МОП-транзисторы и соответственно все N-2
3-х канальные IGBT.База этого транзистора — это область корпуса, которая закорочена на эмиттер, чтобы предотвратить его включение. Однако обратите внимание, что область тела имеет некоторое сопротивление, называемое сопротивлением растеканию области тела, как показано на рисунке 3. Подложка P-типа, а также области дрейфа и корпуса образуют PNP-часть IGBT. Структура PNPN образует паразитный тиристор. Если паразитный транзистор NPN когда-либо включается и сумма коэффициентов усиления транзисторов NPN и PNP больше единицы, происходит фиксация. Блокировка предотвращается за счет конструкции IGBT за счет оптимизации уровней легирования и геометрии различных областей, показанных на рисунке 1.Коэффициенты усиления транзисторов PNP и NPN установлены так, чтобы их сумма была меньше единицы. С повышением температуры увеличивается прирост PNP и NPN, а также сопротивление растеканию области тела. Очень высокий ток коллектора может вызвать достаточное падение напряжения в области тела, чтобы включить паразитный NPN-транзистор, а чрезмерный локальный нагрев кристалла увеличивает коэффициенты усиления паразитного транзистора, поэтому их сумма превышает единицу. В этом случае паразитный тиристор защелкивается, и IGBT не может быть отключен затвором и может быть разрушен из-за перегрева из-за сверхтока.Это статическая фиксация. Высокое значение dv / dt при выключении в сочетании с чрезмерным током коллектора также может эффективно увеличить коэффициент усиления и включить паразитный NPN-транзистор. Это динамическая фиксация, которая на самом деле ограничивает безопасную рабочую зону, поскольку она может происходить при гораздо более низком токе коллектора, чем статическая фиксация, и это зависит от dv / dt при выключении. Оставаясь в пределах максимального тока и безопасной рабочей зоны, можно избежать статического и динамического защелкивания независимо от dv / dt выключения.Обратите внимание, что включение и выключение dv / dt, перерегулирование и вызывной сигнал могут быть установлены с помощью внешнего резистора затвора (а также паразитной индуктивности в схеме схемы). PT по сравнению с технологией NPT. Потери проводимости Для данной скорости переключения технология NPT обычно имеет более высокий V CE (вкл.), Чем технология PT. Эта разница еще больше усиливается тем фактом, что V CE (on) увеличивается с температурой для NPT (положительный температурный коэффициент), тогда как V CE (on) уменьшается с температурой для PT (отрицательный температурный коэффициент).Однако для любого IGBT, будь то PT или NPT, потери переключения снижаются по сравнению с V CE (on). Более высокоскоростные IGBT имеют более высокий V CE (включен); IGBT с более низкой скоростью имеют более низкое значение V CE (включено). Фактически, возможно, что очень быстрое устройство PT может иметь более высокий V CE (on), чем устройство NPT с более медленной скоростью переключения. Потери при переключении Для данного V CE (вкл.) PT IGBT имеют более высокую скорость переключения при более низкой общей энергии переключения. Это связано с более высоким коэффициентом усиления и сокращением срока службы неосновных носителей заряда, что гасит хвостовой ток.Надежность БТИЗ NPT обычно рассчитаны на короткое замыкание, в то время как устройства PT часто не выдерживают этого, а IGBT NPT могут поглощать больше энергии лавин, чем IGBT PT. Технология NPT более надежна из-за более широкой базы и меньшего усиления биполярного транзистора PNP. Это главное преимущество, полученное за счет компромисса между скоростью переключения и технологией NPT. Трудно сделать PT IGBT с напряжением CES более 600 В, тогда как это легко сделать с помощью технологии NPT. Advanced Power Technology предлагает серию очень быстрых IGBT-транзисторов на 1200 вольт, серия Power MOS 7 IGBT.Влияние температуры Для IGBT PT и NPT на скорость включения и потери практически не влияет температура. Однако ток обратного восстановления в диоде увеличивается с увеличением температуры, поэтому температурные эффекты внешнего диода в силовой цепи влияют на потери при включении IGBT. Для БТИЗ NPT скорость выключения и потери переключения остаются относительно постоянными во всем диапазоне рабочих температур. Для PT IGBT скорость выключения снижается, а потери переключения, следовательно, увеличиваются с температурой. Однако из-за гашения концевого тока потери при переключении изначально низкие.Как упоминалось ранее, IGBT NPT обычно имеют положительный температурный коэффициент, что делает их хорошо подходящими для параллельной работы. Для параллельных устройств желателен положительный температурный коэффициент, потому что горячее устройство будет проводить меньший ток, чем более холодное устройство, поэтому все параллельные устройства имеют тенденцию естественным образом делить ток. Однако ошибочно считать, что PT IGBT нельзя использовать параллельно из-за их отрицательного температурного коэффициента. PT IGBT можно подключать параллельно по следующим причинам: их температурные коэффициенты, как правило, почти равны нулю и иногда оказываются положительными при более высоком токе.Разделение тепла через радиатор заставляет устройства делить ток, потому что горячее устройство нагревает своих соседей, тем самым снижая их напряжение. Параметры, влияющие на температурный коэффициент, как правило, хорошо согласовываются между устройствами. IGBT от Advanced Power Technology Advanced Power Technology предлагает три серии IGBT для широкого диапазона приложений: 3
4 Power MOS 7 Series 600 В и 1200 В IGBT с технологией PT, обозначенные GP в номере детали, один из самых быстрых IGBT на рынке, разработанный для работы на высоких частотах и / или для приложений, чувствительных к концевому току, таких как мягкое переключение.Thunderbolt Series 600V только с технологией NPT IGBT, обозначенные GT в номере детали, быстрые IGBT, способные работать на частоте 150 кГц в приложениях с жестким переключением, надежные устройства с защитой от короткого замыкания, подходящие для импульсных источников питания, а также приводов двигателей. БТИЗ Fast Series 600 В и 1200 В с технологией NPT, обозначенные GF в номере детали, защищенные от короткого замыкания устройства с низким напряжением, подходящие для операций жесткого переключения ниже 100 кГц, например, в моторных приводах. БТИЗ Power MOS 7 от APT уникальны тем, что они разработаны для чрезвычайно быстрого переключения и включают в себя запатентованный металлический затвор и структуру с открытыми ячейками.В результате получается чрезвычайно низкое внутреннее эквивалентное сопротивление затвора (EGR), обычно составляющее доли Ом; на один-два порядка ниже, чем у поликремниевых затворных устройств. Низкий уровень рециркуляции отработавших газов обеспечивает более быстрое переключение и, следовательно, меньшие потери переключения. Металлический затвор и структура с открытыми ячейками также приводят к чрезвычайно равномерному и быстрому возбуждению затвора, сводя к минимуму горячие точки во время переходных процессов переключения и повышая надежность. Структура с открытыми ячейками также более устойчива к дефектам, возникающим в процессе производства.Пошаговое руководство по техническому описанию Назначение технических данных, предоставляемых APT, состоит в том, чтобы включить соответствующую информацию, которая будет полезна и удобна для проектировщика силовых цепей, как для выбора подходящего устройства, так и для прогнозирования его производительности в приложении. Графики предоставлены, чтобы позволить проектировщику экстраполировать от одного набора рабочих условий к другому. Однако следует отметить, что результаты испытаний очень сильно зависят от схемы, особенно от паразитной индуктивности эмиттера, но также от паразитной индуктивности коллектора, конструкции и компоновки схемы управления затвором.Различные тестовые схемы дают разные результаты. В следующем пошаговом руководстве приведены определения терминов в таблицах данных APT, а также дополнительные сведения о характеристиках IGBT. Заголовок APT 50 GF 60 B2 R D Комбинированный D, D1, D2, D3, D4: антипараллельный FRED U2 FRED подключен в «повышающей» конфигурации U3 FRED подключен в «понижающей» конфигурации. Не комбинированный, если пустой (только IGBT). R Номинальная энергия лавин: E AS указывается для индуктивного переключения без фиксации (UIS). Энергия лавины не указана, если поле пусто. Пакет K TO-220 B TO-247 B2 T-MAX TM L TO-264 J ISOTOP V Рейтинг CES, разделенный на 10 IGBT Series GP Power MOS 7 IGBT, технология PT GT Thunderbolt IGBT, технология NPT GF Fast IGBT, технология NPT Ток устройства индикатор — не обязательно привязанный к какому-либо параметру таблицы данных, но дает приблизительное представление об используемых текущих возможностях.ISOTOP является зарегистрированным товарным знаком STMicroelectronics Advanced Power Technology. Рис. 4 Нумерация деталей APT для IGBT 4
5 Максимальные номинальные значения В Напряжение коллектор-эмиттер CES Это номинальное значение максимального напряжения между выводами коллектора и эмиттера при замыкании затвора на эмиттер. Это максимальное значение, и в зависимости от температуры максимально допустимое напряжение коллектора может быть меньше номинального значения V CES.См. Описание BV CES в разделе «Статические электрические характеристики». V GE Напряжение затвор-эмиттер V GE — это номинальное максимальное постоянное напряжение между выводами затвора и эмиттера. Целью этого рейтинга является предотвращение пробоя оксида затвора и ограничение тока короткого замыкания. Фактическое напряжение пробоя оксида затвора значительно выше, но постоянное соблюдение этого номинала обеспечивает надежность применения. TJ (max) TC PD = = VCE (on) IC (1) R θ JC Это уравнение просто говорит, что максимальное количество тепла, которое может рассеиваться TT, J (max) C, равно максимальному R θ JC допустимому теплу, выделяемому за счет теплопроводности потери, VCE (on) IC.В I C1 и I C2 отсутствуют коммутационные потери. Решение для I C: I C T = R J (max) θjc V T C CE (on) (2) Конечно, V CE (on) зависит от I C (а также от температуры перехода). За исключением относительно низкого тока, соотношение между I C и V CE (включено) является довольно линейным, как показано на рисунке 5. Таким образом, можно использовать линейное приближение для соотношения I C и V CE (включено). V GEM Переходное напряжение затвора-эмиттера V GEM — это максимальное импульсное напряжение между выводами затвора и эмиттера. Цель этого рейтинга — предотвратить разрушение оксида затвора.Ι CTJ = TJ (макс.) R CE (вкл.) = V CE IC Переходные процессы на затворе могут быть вызваны не только поданным сигналом управления затвором, но часто более значительно из-за паразитной индуктивности в цепи управления затвором, а также обратной связи через затвор -коллекционная емкость. Если на затворе больше звона, чем на V GEM, вероятно, необходимо уменьшить индуктивность паразитной цепи и / или увеличить сопротивление затвора, чтобы снизить скорость переключения. В дополнение к схеме силовой схемы, схема управления затвором имеет решающее значение для минимизации эффективной площади контура управления затвором и возникающих паразитных индуктивностей.См. Рисунок 9. V CE (вкл., Макс.) V CE V CE (ноль) Ι C V CE Если используется фиксирующий стабилитрон, рекомендуется подключать его между драйвером затвора и резистором затвора, а не напрямую с выводом затвора. Отрицательный привод затвора не требуется, но может использоваться для достижения максимальной скорости переключения, избегая включения, вызванного dv / dt. См. Примечание по применению APT9302 для получения дополнительной информации о конструкции привода ворот. I C1, I C2 Непрерывный ток коллектора I C1 и I C2 — это номинальные значения максимального продолжительного постоянного тока при максимальной номинальной температуре перехода кристалла.Они основаны на номинальном термическом сопротивлении перехода к корпусу R θjc и температуре корпуса, как показано ниже: Рис. 5 Линейное приближение I C в зависимости от V CE (вкл.) Кривая V CE (вкл.) Относится к кристаллу при повышенной температуре. (Для расчета значений таблицы данных APT использует максимальное значение V CE (вкл.), Которое выше, чем типичное значение V CE (вкл.), Чтобы учесть нормальные различия между деталями.) Уравнение, связывающее V CE (вкл.) С IC, выглядит следующим образом: VCE ( on) = IC RCE (on) + VCE (ноль) (3) Это уравнение подставляется в (2) для V CE (on), чтобы найти IC: 5
6 IC TJ (макс.) TC TJ (макс.) TC = = RVRIR + V () θjc CE (вкл.) Θjc C CE (вкл.) CE (ноль) TTR θ 2 Дж (макс.) CC CE (вкл.) + C CE (ноль) = (4) JC IRIV Это в форме известного квадратного уравнения 2 b ± b 4 acx = с 2a (TJ (max) TC) a = R CE (on), b = V CE (ноль) , и c =.Решение: IC = R θ JC 2 J (max) C VCE (ноль) + VCE (ноль) + 4 RCE (вкл.) R θjc 2R CE (вкл.) TT (5) IC в (5) представляет собой непрерывный постоянный ток. ток (при полностью включенном устройстве), который вызывает нагрев кристалла до максимальной номинальной температуры перехода. I C1 — решение (5) с T C, равным 25 ºC. I C2 — это решение (5) с T C при повышенной температуре. Это более полезный рейтинг, чем традиционный рейтинг I C1, поскольку работа при температуре корпуса всего 25 ºC редко возможна, однако I C2 по-прежнему не учитывает коммутационные потери.График зависимости I C от T C Чтобы помочь разработчикам в выборе устройств для конкретного приложения, APT предоставляет график зависимости максимального тока коллектора от температуры корпуса. Этот график представляет собой просто решение (5) в диапазоне температур корпуса. На рисунке 6 показан пример. Обратите внимание, что в этом случае провода корпуса ограничивают ток до 100 А при низкой температуре, а не кристалл. Рисунок 6 Максимальный ток коллектора в зависимости от температуры корпуса с использованием номиналов I C1 и I C2 Номинальные значения I C1 и I C2 и график максимального тока коллектора в зависимости от температуры корпуса просто показывают максимальный теоретический непрерывный постоянный ток, который может выдерживать устройство, на основе максимальное тепловое сопротивление перехода к корпусу.Их цель — в основном как показатели качества для сравнения устройств. Для приложения с плавным переключением I C2 — хорошая отправная точка для выбора устройства. В приложениях с жестким или мягким переключением устройство может безопасно пропускать больший или меньший ток в зависимости от: коммутационных потерь, рабочего цикла, частоты переключения, скорости переключения, теплоотводящей способности, теплового сопротивления и переходных процессов. Дело в том, что вы не можете просто предположить, что устройство может безопасно переносить тот же ток в импульсном преобразователе мощности, который указан в номинальных значениях I C1 или I C2 или на графике зависимости максимального тока коллектора от температуры корпуса.APT предлагает поддержку приложений, если вам требуется помощь в выборе устройств или модулей, подходящих для вашего приложения. I CM Pulsed Collector Current Этот рейтинг показывает, какой импульсный ток может выдержать устройство, что значительно превышает номинальный постоянный постоянный ток. Цели рейтинга I CM: поддерживать работу IGBT в линейной области его передаточной характеристики. См. Рисунок 7. Существует максимальный ток коллектора для соответствующего напряжения затвор-эмиттер, которое будет проводить IGBT.Если рабочая точка при заданном напряжении затвор-эмиттер превышает изгиб линейной области на Рисунке 7, любое дальнейшее увеличение тока коллектора приводит к значительному увеличению напряжения коллектор-эмиттер и, как следствие, увеличению потерь проводимости и возможному разрушению устройства. Рейтинг I CM устанавливается ниже колена для типичных напряжений управления затвором. Чтобы предотвратить выгорание или схватку. Даже если ширина импульса теоретически слишком мала для перегрева кристалла, значительное превышение рейтинга I CM может вызвать достаточный локальный нагрев элемента кристалла, что приведет к перегоранию или защелкиванию.Чтобы предотвратить перегрев кристалла. Сноска Рейтинг повторяемости: ширина импульса, ограниченная максимальной температурой перехода, подразумевает, что I CM основан на тепловом ограничении, зависящем от ширины импульса. Это всегда верно по двум причинам: 1) существует некоторый запас в рейтинге I CM до риска 6
7 повреждений, кроме превышения максимальной температуры перехода кристалла, и 2) независимо от того, каков на самом деле механизм отказа, перегрев почти всегда является наблюдаемым конечным результатом.Чтобы избежать проблем с чрезмерным током через соединительные провода, хотя, вероятно, сначала возникнут проблемы, связанные с чрезмерным током через кристалл. BV CES i C 0 0 Линейная область Активная область Увеличение V GE V GE4 V GE3 V GE2 V GE1 BV CES Рисунок 7 Передаточная характеристика IGBT Что касается теплового ограничения на I CM, повышение температуры зависит от ширины импульса, времени между импульсами, рассеивания тепла , и V CE (вкл.), а также форму и величину импульса тока. Простое соблюдение предела I CM не гарантирует, что максимальная температура перехода не будет превышена.См. Обсуждение кривой максимального эффективного переходного теплового импеданса для процедуры оценки температуры перехода во время импульса тока. I Зоны безопасной эксплуатации LM, RBSOA и SSOA Все эти рейтинги взаимосвязаны. I LM — это величина ограниченного индуктивного тока нагрузки, которую устройство может безопасно переключать в приложении жесткого переключения без демпфера. Указаны условия испытательной схемы (температура корпуса, сопротивление затвора, напряжение зажима и т. Д.). Номинал I LM ограничен переходным процессом выключения, когда затвор был смещен положительным смещением и переключается на нулевое или отрицательное смещение.Следовательно, рейтинг I LM и зона безопасной работы при обратном смещении (RBSOA) аналогичны. Рейтинг I LM — это максимальный ток, RBSOA — максимальный ток при заданном напряжении. Безопасная рабочая зона переключения (SSOA) — это просто RBSOA при полном номинальном напряжении V CES. Безопасная рабочая зона с прямым смещением (FBSOA), охватывающая переходные процессы при включении, обычно намного выше, чем RBSOA, и поэтому обычно не указывается в таблице данных. v CE Разработчику схемы не нужно беспокоиться о демпферах, минимальном сопротивлении затвора или ограничениях на dv / dt, если эти номинальные значения не превышаются.E AS — лавинная энергия за один импульс Все устройства, рассчитанные на лавинную энергию, имеют рейтинг E AS. Номинальная энергия лавины является синонимом номинальной индуктивной коммутации без фиксации (UIS). E AS ограничен как по температуре, так и по дефектам и указывает, сколько энергии обратной лавины устройство может безопасно поглотить при температуре корпуса 25 ºC и кристалле при максимальной номинальной температуре перехода или ниже. Структура с открытыми ячейками, используемая в Power MOS 7, снижает ограничение дефектов на E AS. С другой стороны, дефект в структуре закрытых ячеек может привести к защелкиванию ячейки в условиях лавины.Не используйте IGBT намеренно в лавинообразном состоянии без тщательного тестирования. Условия для испытательной схемы указаны в сноске, и 2 Li рейтинг E AS равен C, где L — значение 2 индуктора, несущего пиковый ток i C, который внезапно отводится на коллектор испытуемого устройства. . Напряжение катушки индуктивности, превышающее напряжение пробоя IGBT, вызывает лавинообразное состояние. Состояние лавины позволяет току индуктора течь через IGBT, даже если IGBT находится в выключенном состоянии.Энергия, запасенная в индукторе, аналогична энергии, запасенной в индуктивностях рассеяния и / или паразитных индуктивностей, и рассеивается в испытуемом устройстве. В приложении, если звон из-за рассеяния и паразитной индуктивности не превышает напряжения пробоя, то устройство не будет лавинообразно и, следовательно, не должно рассеивать лавинную энергию. Устройства, рассчитанные на лавинную энергию, обеспечивают защиту в зависимости от разницы между номинальным напряжением устройства и напряжениями системы, включая переходные процессы. P D Общая рассеиваемая мощность Это номинальная максимальная мощность, которую устройство может рассеять, и основывается на максимальной температуре перехода и тепловом сопротивлении R θjc при температуре корпуса 25 ºC.TJ (max) TC PD = (6) R θ JC При температурах выше 25 ºC коэффициент линейного снижения мощности просто обратен R θjc. 7
8 T J, T STG Диапазон рабочих температур спая при хранении Это диапазон допустимых температур спая при хранении и эксплуатации. Пределы этого диапазона установлены для обеспечения минимально допустимого срока службы устройства. Работа за пределами этого диапазона может значительно увеличить срок службы.Фактически, это экспоненциальная функция, связывающая срок службы устройства с температурой перехода, но, как показывает опыт, только для термических эффектов, каждые 10 ºC снижения температуры перехода удваивают срок службы устройства. Статические электрические характеристики BV CES Напряжение пробоя коллектор-эмиттер Измерение фактического напряжения пробоя коллектор-эмиттер практически невозможно без разрушения устройства. Следовательно, BV CES — это напряжение коллектор-эмиттер, при котором не больше указанного тока коллектора будет протекать при указанной температуре.Это отслеживает фактическое напряжение пробоя. RBV CES Обратное напряжение пробоя коллектор-эмиттер Это спецификация обратного напряжения пробоя коллектор-эмиттер, то есть когда напряжение эмиттера положительно по отношению к коллектору. Как и в случае BV CES, RBV CES — это напряжение эмиттер-коллектор, при котором не будет течь не более указанного тока эмиттера при указанной температуре. Типичное значение составляет около 15 Вольт, однако RBV CES часто не указывается, поскольку IGBT не предназначен для блокировки обратного напряжения.Хотя теоретически NPT IGBT может блокировать столько же обратного напряжения, сколько и прямого, в целом это невозможно из-за производственного процесса. PT IGBT не может блокировать очень много обратного напряжения из-за n + буферного слоя. V GE (th) Пороговое напряжение затвора Это напряжение затвор-исток, при котором начинает течь ток коллектора. Также указаны условия испытаний (ток коллектора, напряжение коллектор-эмиттер, температура перехода). Все MOS-стробированные устройства демонстрируют изменение V GE (th) между устройствами, что является нормальным явлением.Поэтому указывается диапазон V GE (th), при этом минимум и максимум представляют границы распределения V GE (th). V GE (th) имеет отрицательный температурный коэффициент, что означает, что по мере нагрева кристалла IGBT будет включаться при более низком напряжении затвор-эмиттер. Этот температурный коэффициент обычно составляет около минус 12 мВ / ºC, как и для силового MOSFET. V CE (on) Напряжение включения коллектор-эмиттер Это напряжение коллектор-эмиттер на IGBT при заданном токе коллектора, напряжении затвор-эмиттер и температуре перехода.Поскольку V CE (вкл.) Зависит от температуры, он указан как при комнатной температуре, так и при высокой температуре. Рисунок 8 Нормализованное напряжение пробоя в зависимости от температуры перехода Как показано на рисунке 8, BV CES имеет положительный температурный коэффициент. При фиксированном токе утечки IGBT может блокировать большее напряжение в горячем состоянии, чем в холодном. Фактически, в холодном состоянии спецификация BV CES ниже, чем рейтинг V CES. Для примера, показанного на Рисунке 8, при -50 ºC BV CES составляет около 93% от номинальной спецификации 25 ºC. Предоставляются графики, которые показывают отношения между типичным (не максимальным) напряжением коллектор-эмиттер и током коллектора, температурой и напряжением затвор-эмиттер.По этим графикам разработчик схем может оценить потери проводимости и температурный коэффициент V CE (on). Потеря мощности проводимости равна V CE (вкл.), Умноженному на ток коллектора. Температурный коэффициент — это наклон V CE (вкл.) В зависимости от температуры. БТИЗ NPT имеют положительный температурный коэффициент, что означает, что по мере увеличения температуры перехода V CE (вкл.) Увеличивается. С другой стороны, PT IGBT имеют слегка отрицательный температурный коэффициент. Для обоих типов температурный коэффициент имеет тенденцию к увеличению с увеличением тока коллектора.По мере увеличения тока температурный коэффициент PT IGBT может фактически переходить с отрицательного на положительный. 8
9 I CES Ток отсечки коллектора Это ток утечки, который течет от коллектора к эмиттеру, когда устройство выключено, при заданном напряжении коллектора-эмиттера и затвора-эмиттера. Поскольку ток утечки увеличивается с ростом температуры, I CES указывается как при комнатной температуре, так и при высокой температуре.Потеря мощности утечки равна I CES, умноженному на напряжение коллектор-эмиттер. I Ток утечки затвор-эмиттер GES Это ток утечки, который протекает через клемму затвора при заданном напряжении затвор-эмиттер. Динамические характеристики На рис. 9 показана эквивалентная модель IBGT, которая включает емкости между выводами. Входная, выходная и обратная передаточные емкости представляют собой комбинации этих емкостей. См. Примечание по применению APT0103 для получения более подробной информации. Условия испытаний для измерения емкости указаны в таблице данных.C oes Output Capacitance Это выходная емкость, измеренная между клеммами коллектора и эмиттера при замыкании затвора на эмиттер для переменного напряжения. C oes состоит из емкости коллектор-эмиттер (C CE), параллельной емкости затвор-коллектор (C GC), или Coes = CCE + CGC. схема. C res обратная передаточная емкость. Это обратная передаточная емкость, измеренная между клеммами коллектора и затвора, когда эмиттер подключен к земле.Емкость обратной передачи равна емкости затвор-коллектор. C res = C GC Напряжение питания затвора C GC C Емкость обратной передачи, часто называемая емкостью Миллера, является одним из основных параметров, влияющих на время нарастания и спада напряжения во время переключения. Схема возбуждения затвора R G G C CE Минимизируйте эту область C GE — Дополнительное отрицательное напряжение питания затвора + ECies состоит из емкости затвор-коллектор (C GC), параллельной емкости затвор-эмиттер (C GE), или Cies = CGE + CGC Входная емкость должна быть заряжена до порогового напряжения, прежде чем устройство начнет вращаться. включен и разряжается до плато до того, как устройство начнет выключаться. Следовательно, импеданс схемы возбуждения и Cies имеют прямую зависимость от задержек включения и выключения. Рисунок 10 Зависимость емкости от напряжения коллектор-эмиттер На рисунке 10 показан пример графика зависимости типичных значений емкости от напряжения коллектор-эмиттер.Емкости уменьшаются в диапазоне увеличения напряжения коллектор-эмиттер, особенно выходная емкость и емкость обратной передачи. Как будет объяснено, это изменение является причиной для данных заряда затвора. 9
Плато напряжения GEP 10 В На рис. 11 показано напряжение затвор-эмиттер как функция заряда затвора. Последовательность включения пересекает эту кривую слева направо, выключение — справа налево.Метод измерения заряда затвора описан в стандарте JEDEC.Напряжение плато затвора V GEP определяется как напряжение затвор-эмиттер, когда наклон напряжения затвор-эмиттер сначала достигает минимума во время переключения включения для постоянного тока затвора. состояние привода. Другими словами, это напряжение затвор-эмиттер, при котором кривая заряда затвора сначала выпрямляется после первого перегиба кривой, как показано на рисунке 11. Альтернативно, V GEP — это напряжение затвор-эмиттер при последнем минимальном наклоне во время поворота. -выкл.Напряжение плато увеличивается с током, но не с температурой. Остерегайтесь замены силовых MOSFET на IGBT. Привод затвора на 10 или 12 В может нормально работать с силовым полевым МОП-транзистором высокого напряжения, но в зависимости от его плато напряжения IGBT при высоком токе может переключаться на удивление медленно или даже не включиться полностью, если напряжение привода затвора не будет увеличено. часто используется для проектирования схемы управления затвором, поскольку он учитывает изменения емкости при изменении напряжения во время переходного процесса переключения.См. Примечание по применению APT0103 для получения дополнительной информации о затворе. Время и энергия переключения Рисунок 12 Схема испытания на индуктивную коммутационную потерю Q g Напряжение затвора V GE (pl) Q gc Напряжение затвор-исток = пиковое напряжение возбуждения 10% td (on) tr Ток коллектора TJ = 125 CQ ge 90% заряда (nc) 5% 10% 5% Напряжение коллектора Рис. 11 v GE как функция заряда затвора Q ge, Q gc и Q g Заряд затвора Как показано на рисунке 11, Q ge — это заряд от начала координат до первого перегиба кривой, Q gc — это заряд от первого до второго перегиба кривой (также известный как заряд Миллера), а Q g — это заряд от начала координат до точки на кривой, в которой v GE равно пиковому напряжению возбуждения.Значения заряда затвора зависят от тока коллектора и напряжения коллектор-эмиттер, но не от температуры. Уточняются условия испытаний. Кроме того, в таблицу данных обычно включается график заряда затвора, показывающий кривые заряда затвора для фиксированного тока коллектора и различных напряжений коллектор-эмиттер. Значения заряда затвора отражают заряд, накопленный на межконтактных емкостях, описанных ранее. Заряд затвора — это энергия переключения. Рис. 13 Формы сигналов и определения при включении Время и энергию переключения не всегда легко предсказать для IGBT, поэтому APT предоставляет время переключения и энергию в таблице данных для жестко коммутируемого фиксированного индуктивного переключения.Испытательные схемы и определения включены в каждое техническое описание. На рисунке 12 показана испытательная схема, используемая для измерения времени переключения и энергии, а на рисунке 13 показаны соответствующие формы сигналов и определения. Следующие условия испытаний указаны в таблице динамических характеристик: V CC на рисунке 12, ток индуктора, напряжение управления затвором, сопротивление затвора и температура перехода. Обратите внимание, что сопротивление затвора включает сопротивление IC драйвера затвора. С момента переключения и энергии 10
11 зависят от температуры (кроме E on1), данные представлены как при комнатной температуре, так и при высокой температуре.Также часто предоставляются графики, показывающие взаимосвязь между временем переключения и энергией с током коллектора, температурой перехода и сопротивлением затвора. В общем, скорость и энергия включения относительно не зависят от температуры или фактически увеличиваются в скорости (уменьшаются в энергии) очень незначительно с повышением температуры. Ток обратного восстановления диода увеличивается с температурой, что приводит к увеличению E on2 с температурой. E on1 и E on2 определены ниже. Скорость выключения уменьшается с повышением температуры, что соответствует увеличению энергии выключения.Скорость переключения, как при включении, так и при выключении, уменьшается с увеличением сопротивления затвора, что соответствует увеличению энергии переключения. Энергию переключения можно масштабировать непосредственно для изменения между напряжением приложения и испытательным напряжением энергии переключения, указанным в таблице данных. Поэтому, если тесты в таблице данных проводились, например, при 400 В, а приложение — на 300 В, просто умножьте значения энергии переключения из таблицы на соотношение 300/400 для экстраполяции. Время и энергия переключения также сильно зависят от паразитных индуктивностей в цепи, включая схему управления затвором.В частности, паразитная индуктивность последовательно с эмиттером существенно влияет на время и энергию переключения. Таким образом, время переключения и значения энергии и графики в таблице данных являются только репрезентативными и могут отличаться от наблюдаемых результатов в фактическом источнике питания или схеме привода двигателя. t d (вкл.), Время задержки включения Время задержки включения — это время от момента, когда напряжение затвор-эмиттер превышает 10% напряжения привода, до момента, когда ток коллектора превышает 10% указанного тока катушки индуктивности.См. Рисунок 13. t d (выкл.), Время задержки выключения Время задержки выключения — это время от момента, когда напряжение затвор-эмиттер падает ниже 90% напряжения привода, до момента, когда ток коллектора падает ниже 90% указанного тока катушки индуктивности. Это указывает на задержку до начала перехода тока в нагрузке. См. Рисунок 14. t r Время нарастания тока Время нарастания тока — это время между повышением тока коллектора с 10% до 90% от начала до прекращения указанного тока индуктора. См. Рисунок 13. t f Время спада тока Время спада тока — это время между падением тока коллектора с 90% до 10% от начала до остановки указанного тока катушки индуктивности.См. Рисунок 14. E on2 Энергия переключения при включении с диодом Это ограниченная индуктивная энергия включения, которая включает ток обратного восстановления коммутирующего диода в потери переключения при включении IGBT. Комбинированное устройство (IGBT в сочетании с антипараллельным диодом) с IGBT того же типа, что и тестируемое устройство, используется для ограничивающего диода, как показано в испытательной схеме на Рисунке 12. Энергия переключения при включении является интегралом произведения тока коллектора. и напряжение коллектор-эмиттер в интервале от момента, когда ток коллектора превышает 5% испытательного тока, до момента, когда напряжение падает ниже 5% испытательного напряжения.Определения 5% нарастания тока и падения напряжения для интервала интегрирования в осциллограммах на Рисунке 13 учитывают разрешающую способность прибора, обеспечивая при этом надежные средства дублирования измерений, не снижающие точности. t d (выкл.) 90% t f 90% 10% Напряжение затвора Коллекторное напряжение Коллекторный ток Коммутационная энергия T J = 125 C Рис. 14 Формы и определения сигналов при выключении E off Энергия при выключении Это зафиксированная индуктивная энергия выключения. На рисунке 12 показана тестовая схема, а на рисунке 14 показаны формы сигналов и определения.E off — это интеграл произведения тока коллектора и напряжения коллектор-эмиттер за интервал, начиная с момента, когда напряжение затвор-эмиттер падает ниже 90%, до момента, когда ток коллектора достигает нуля. Это соответствует стандарту JEDEC 24-1 для измерения энергии выключения. В старых таблицах данных указано значение E off, измеренное с начала переходного процесса и продолжающееся в течение 2 мкс. Метод, используемый для каждого устройства, показан в его техническом описании. 0 11
12 E on1 Энергия переключения при включении Это ограниченная индуктивная энергия включения только IGBT, без эффекта коммутирующего диодного тока обратного восстановления, добавляемого к потерям при включении IGBT.На рисунке 15 показана тестовая схема. Определение интервала интегрирования E on1 такое же, как для E on2 на рисунке 13. Электрическая модель используется для прогнозирования повышения температуры на основе потери мощности в установившемся режиме, как показано на рисунке 16. Потери мощности устройства (Вт) TJ (ºC) R ΘJC (ºC / Вт) TC (ºC) Рисунок 16 Модель теплового сопротивления Потери мощности, смоделированные как ток, протекающий через тепловое сопротивление, смоделированное как резистор, создают повышение температуры, которое моделируется как повышение напряжения. Дополнительные резисторы могут быть добавлены последовательно для моделирования теплового сопротивления между корпусом и стоком и между стоком и окружающей средой.Температура в различных физических точках аналогична напряжению в узлах модели цепи теплового сопротивления. Таким образом, в установившемся режиме температура перехода может быть рассчитана как TJ = TC + PLoss R θ JC (7) Рисунок 15 E on1 Испытательная схема g fe Прямая крутизна Прямая крутизна связывает ток коллектора с напряжением затвор-эмиттер. Прямая крутизна зависит от тока коллектора, напряжения коллектор-эмиттер и температуры. Высокая крутизна соответствует низкому напряжению плато и быстрому нарастанию и спаду тока.Крутизна важна для биполярных транзисторов. IGBT, с другой стороны, термически ограничены задолго до того, как крутизна упадет, поэтому эта спецификация не так уж и полезна. Однако важно отметить, что IGBT демонстрируют относительно высокий коэффициент усиления даже при высоком напряжении затвор-эмиттер. Это связано с тем, что увеличение потока электронов за счет увеличения напряжения затвор-эмиттер также увеличивает поток дырок. Однако коэффициент усиления высоковольтного силового полевого МОП-транзистора очень нечувствителен к напряжению затвора, когда он полностью включен.Термические и механические характеристики R θjc Термическое сопротивление перехода к корпусу Это тепловое сопротивление от стыка матрицы к внешней стороне корпуса устройства. Тепло является результатом потери мощности в самом устройстве, а тепловое сопротивление определяет, насколько нагревается кристалл в зависимости от этой потери мощности. Это называется тепловым сопротивлением, потому что потеря мощности устройства складывается из усредненных потерь на переключение, теплопроводность и утечку. Как правило, потерями от утечки можно пренебречь. Поскольку тепловое сопротивление между корпусом и раковиной и между стоком и окружающей средой полностью зависит от области применения (термические соединения, тип радиатора и т. Д.)), в таблице указано только R θjc. Иногда также указывается R θja, хотя для типичных приложений всегда требуется теплоотвод. Такие характеристики, как максимальный непрерывный постоянный ток, общая рассеиваемая мощность и зависимость частоты от тока, основаны на максимальном значении R θjc. Используется максимальное значение R θjc, поскольку оно включает запас для учета нормальных производственных отклонений, а также обеспечивает некоторый запас по применению. В отрасли наблюдается тенденция к уменьшению разницы между максимальным значением R θjc и типичным значением, которое обычно не публикуется.Z θjc Соединение с корпусом Тепловое сопротивление Тепловое сопротивление — это динамический родственник теплового сопротивления. Термический импеданс учитывает теплоемкость устройства, поэтому его можно использовать для оценки мгновенных температур, возникающих в результате потери мощности на переходной основе. Переходный тепловой импеданс определяется путем подачи на устройство импульсов мощности различной величины и длительности. Результат — переходный 12
13 семейство кривых импеданса, пример которого показан на рисунке 17.Обратите внимание, что семейство кривых основано на максимальном значении R θjc, которое включает запас, как обсуждалось ранее. Метод расчета пиковой температуры перехода показан на рисунке 17. Для непрямоугольных импульсов мощности необходимо использовать кусочно-линейную аппроксимацию. Рис. 17 Семейство кривых теплового импеданса. Зависимость полезной частоты от тока. Кривая зависимости полезной частоты от тока — это один из наиболее полезных элементов в таблице данных. Несмотря на то, что он ограничен определенными условиями, указанными в техническом описании (индуктивное жесткое переключение, нагрузка 50%, фиксированная температура корпуса и перехода, фиксированный испытательный ток, напряжение и сопротивление затвора), он обеспечивает реалистичное представление о том, как устройство будет работать в приложение.Тенденция в отрасли, вероятно, будет заключаться в использовании полезной частоты в зависимости от силы тока в качестве показателя качества для сравнения устройств, а не столько полагаться на рейтинги I C1 и I C2. период переключения. В большинстве случаев это разумное ограничение, которое можно проверить с помощью анализа переходных процессов. Возникает вопрос: каково общее время переключения? Его можно оценить, сложив время задержки включения и выключения, а также время нарастания и спада тока. Изучение форм сигналов переключения на рисунках 13 и 14 показывает, что это дает хорошее приближение к общему времени переключения.Не учитывается только время падения напряжения при включении, но оно относительно короткое. В любом случае ограничение периода переключения на 5% от общего времени переключения обеспечивает достаточный запас для этого приближения. Таким образом, максимальная частота, основанная на минимальной ширине импульса, равна. В приложении с жестким индуктивным переключением частота переключения ограничена минимальной и максимальной шириной импульса, а также потерями проводимости и коммутации. Ограничение длительности импульса связано с переходным тепловым откликом кристалла.Переходные процессы при обратном переключении не позволяют кристаллу остыть между большими резкими всплесками потери мощности переключения. Кроме того, постоянное недопущение завершения переходного процесса до переключения в другую сторону может привести к перегреву кристалла. В зависимости от рабочих температур и переходного теплового импеданса переходная муфта может перегреться, даже если рабочий цикл очень мал. Ограничение минимального рабочего цикла является проблемой для моторных приводов, например, в электромобиле, где при очень низкой мощности требуется исключительно маленький рабочий цикл, если частота переключения не падает до слышимого диапазона или не используется какой-либо тип схемы пропуска импульсов. реализовано.Чтобы достичь предела частоты, основанного на минимальной ширине импульса, APT определяет минимальный предел ширины импульса, так что общее время переключения (сумма времени включения и выключения) не должно превышать 5% от f max = = T t + t + t + tsd (on) d (off) rf Тепловой предел частоты определяется следующим образом: P dis JC on2 off cond Rθ JC tdiss (8) TTE + E = = P + (9) P cond — это потери мощности проводимости (ток коллектора, умноженный на V CE (on), при этом токе коллектора, умноженный на рабочий цикл), а t dis — минимальное время, в течение которого E on2 и E off могут рассеиваться для поддержания заданной температуры перехода.Поскольку потери проводимости основаны на предположении о фиксированном рабочем цикле 50%, они не зависят от частоты. Однако чем выше потери проводимости, тем больше времени требуется для рассеивания потерь при переключении. Таким образом, величина, обратная t dis, — это максимальная частота, которую мы ищем. f max 2 TJ TC P 1 R θjc = = t E + E дисс вкл2 выкл cond (10) 13
14 Наконец, максимальная частота коммутации при заданном токе коллектора — это просто минимум f max1 и f max2.Частота обычно ограничена термически, за исключением очень низкого тока. Поскольку частота, скорее всего, будет ограничена термически, мы начнем с вычисления f max2. Из графика выходных характеристик, показанного на рисунке 19, мы можем найти V CE (вкл.) При 125 ºC, что будет примерно таким же, как при 112 ºC. Рисунок 18 Зависимость максимальной частоты от тока На рисунке 18 показан пример кривой зависимости частоты от тока для 600-вольтного IGBT PT. Следует еще раз отметить, что эта кривая предназначена для индуктивного жесткого переключения при одном конкретном наборе условий как для тестируемого устройства (DUT), так и для ограничивающего диода.Пример экстраполяции таблицы данных Предположим, что в приложении импульсного источника питания мы хотим жестко переключить 20 А на 200 кГц при 300 В и рабочем цикле 35%. Напряжение управления затвором составляет 15 Вольт, а резистор управления затвором — 15 Ом. Кроме того, предположим, что мы хотим, чтобы температура соединения достигала 112 ºC, но при этом поддерживаем температуру корпуса 75 ºC. Для устройства на 600 В существует запас 300 В между напряжением приложения и В CES, поэтому лавинная устойчивость не требуется. Возможность короткого замыкания также не требуется.Это мостовая конфигурация, поэтому требуется Combi со встроенным антипараллельным диодом. Какое устройство будет работать? Рисунок 19 Зависимость тока коллектора от напряжения коллектор-эмиттер При 20 А и 125 ºC напряжение CE (вкл.) Составляет около 2,1 вольт. Таким образом, потеря проводимости при 20 А составляет около 14,7 Вт. Полная рассеиваемая мощность TJ TC = 137 Вт. Теперь нам нужны E on2 и Rθ JC 0,27 E при 112 ºC и сопротивлении затвора 15 Ом. Мы можем получить это из графика зависимости энергии переключения от сопротивления затвора, показанного на рисунке 20.Поскольку это относительно высокочастотное приложение, не требующее очень прочного устройства, серия Power MOS 7 будет лучшим выбором. Похоже, устройство, для которого был создан график зависимости полезной частоты от тока на рисунке 18, может работать. Однако условия применения не соответствуют условиям тестирования, указанным в таблице данных. Мы можем экстраполировать результаты таблицы, чтобы увидеть, подойдет ли она для приложения. Рисунок 20 Энергия переключения в зависимости от сопротивления затвора 14
15 При 125 ºC, 20 А и 15 Ом E on2 находится где-то между значениями E on2 15 и 30 А, равными 300 и 700 мкДж.Назовите это 500 мкДж. E off будет около 270 мкДж. При 112 ºC эти значения будут немного меньше этого. Рисунок 21 Зависимость энергии переключения от температуры Посмотрев на рисунок 21, мы видим, что E on2 и E off при 112 ºC составляют около 80% от их значений при 125 ºC. Таким образом, E on2 и E off будут примерно 400 и 216 мкДж соответственно. Наконец, мы должны отрегулировать разницу в напряжении. Испытательное напряжение, указанное в паспорте, составляет 400 Вольт, напряжение приложения — всего 300 Вольт. Таким образом, мы просто масштабируем E на 2 и E соответственно.300 Eon2 = 400 мкДж = 300 мкДж и Eoff = 216 мкДж = 162 мкДж. 400 Так как это превышает нашу цель в 200 кГц, пока кажется, что это устройство может работать. На самом деле нет необходимости экстраполировать, какое значение f max1 будет для условий применения, по сравнению с условиями тестирования в таблице данных. Вместо этого можно использовать графики времени задержки и времени нарастания и спада тока, чтобы получить представление о том, насколько быстро устройство будет переключаться. Кроме того, ограничение f max1 вступает в игру только при относительно низком токе. Фактически, для некоторых устройств максимальная частота всегда ограничена термически (f max2 всегда меньше f max1).Важно отметить, что графики таблицы данных представляют типичные данные. Между частями и, конечно же, тестовыми цепями есть некоторые нормальные различия. В этом примере экстраполяции запас в 32%, по крайней мере, с точки зрения рабочей частоты. Что действительно важно, так это то, как устройство работает в приложении, и результаты показывают, что это устройство, безусловно, стоит протестировать. Если требуется больше конструктивного запаса, то было бы неплохо протестировать и следующее более крупное устройство.Поэтому следующим шагом будет звонок торговому представителю APT, чтобы получить несколько устройств для тестирования. Теперь мы можем вычислить f max2: fmax 2 = = Hz () 15
Как найти замену MOSFET || AllTransistors.com
Для большинства MOSFET транзисторов достаточно найти аналог, близкий по своим параметрам.Часто это невозможно заменить неисправный MOSFET-транзистор на такой же. В этом случае, чтобы найти аналог, необходимо сделать следующее:
- Полное название транзистора узнайте по его этикетке. Для MOSFET-транзисторов в корпусе SMD можно узнать укажите на MOSFET-транзисторе маркировку: SMD-коды 🔗.
- Изучите схему подключения MOSFET-транзистора для определения его режима работы (ключ в схемах переключения, импульсное устройство, линейный стабилизатор и т. Д.).
- Найдите лист данных с описанием неисправного транзистора.
- Заполните поля формы выбора транзисторного аналога.
- Выбрать наиболее подходящий аналог MOSFET-транзистора из предложенных вариантов с учетом режима его работы в устройстве.
На что следует обратить внимание?
Открыв техническое описание в формате PDF, сначала необходимо выяснить тип транзистора (MOSFET или JFET), полярность, тип корпуса и Конфигурация контактов (распиновка).
Из числовых параметров это, во-первых, предельные характеристики, такие как Pd (максимальная мощность рассеивания), Vds (максимальное напряжение сток-исток), Vgs (максимальное напряжение затвор-исток) и Id (максимальный ток стока). Выбранный транзистор не должен иметь параметров меньше, чем у исходного транзистора.
Сопротивление сток-исток открытого транзистора (Rds) является важным параметром MOSFET-транзистора. Мощность, выделяемая на транзистор, зависит от от значения Rds.Чем меньше значение Rds, тем меньше будет нагреваться транзистор.
Необходимо учитывать, что чем выше Id и ниже Rds, тем больше емкость затвора полевого МОП-транзистора. Это приводит к необходимости большей мощности для управления этими воротами.
Если схема не обеспечивает необходимую мощность, то динамические потери увеличиваются из-за низкой скорости переключения транзисторов (МОП-транзистор будет нагреваться сильнее). Так что необходимо проверить нагрев транзистора после включения устройства.Если транзистор сильно нагревается, то проблема может скрываться как внутри самого транзистора, так и внутри элементов его привязки.
Расшифровка основных параметров MOSFET транзисторов
Тип транзистора — в реальных устройствах могут использоваться различные типы транзисторов: JFET или MOSFET.
Электрическая полярность — полевые транзисторы могут иметь прямую или обратную проводимость (P- или N-канальный).
Максимальное рассеивание мощности (Pd) — необходимо убедиться, что выбранный транзистор может рассеивать достаточную мощность.Этот параметр зависит от максимальной рабочей температуры транзистора — при повышении температуры максимальная рассеиваемая мощность уменьшается. Если максимальной мощности рассеивания не хватает — ухудшаются некоторые характеристики транзистора. Например, сопротивление Rds может удваиваться как температура. повышается с 25 ° C до 125 ° C.
Напряжение пробоя сток-исток (Vds) — максимальное напряжение сток-исток, не вызывающее лавинного пробоя при 25 ° C. Это зависит от температуры: напряжение падает, если температура транзистора тоже понижается.Например, при -50 ° C напряжение, не вызывающее лавинный пробой может составлять 90% от Vds при 25 ° C. Максимально доступное напряжение сток-исток (Vgs) — когда более доступное напряжение приложено к затвору, возможно повреждение изолирующего оксидного слоя затвора (это также может быть статическое электричество). Не следует использовать транзисторы с большим резервированием Vds и Напряжения Vgs, потому что обычно у них худшие скоростные характеристики.
Gate Threshold Voltage Vgs (th) — если напряжение на затворе выше, чем Vgs (th), MOSFET-транзистор начинает проводить ток через канал сток-исток.Vgs (th) имеет отрицательный температурный коэффициент: при повышении температуры MOSFET-транзистор начинает открываться при более низкой температуре. напряжение затвор-исток.
Continuous Drain Current (Id) — следует иметь в виду, что некоторые выходы из корпуса транзистора ограничивают максимально доступный постоянный ток стока (ток переключения может быть больше). При повышении температуры максимально доступный ток уменьшается.
Максимальная температура перехода (Tj) — этот параметр ограничивает температуру канала транзистора во включенном состоянии.Если оно превышено, срок службы транзистора может сократиться.
Rise Time (tr) — время, за которое ток стока увеличивается с 10% до 90% от заданного.
Сопротивление в открытом состоянии сток-исток (Rds) — это сопротивление открытого канала сток-исток для установленных параметров: Id, Vgs и Tj.
Выше приведены наиболее важные параметры MOSFET-транзисторов. Производитель указывает в даташитах множество дополнительных параметров: заряд затвора, ток утечки затвора, импульсный ток стока, емкость и т. д.
Важные соображения, которые следует учитывать при установке полевого МОП-транзистора
При работе с MOSFET-транзисторами необходимо учитывать, что они очень чувствительны к статическому электричеству. Перед установкой одного на печатную плату необходимо соединить транзисторные выходы между собой тонким проводом.


 Например из серии IRL630A или им подобные. У них открывающие напряжения привязаны к логическим уровням. У них правда есть один недостаток — их порой сложно достать. Если обычные мощные полевики уже не являются проблемой, то управляемые логическим уровнем бывают далеко не всегда.
Например из серии IRL630A или им подобные. У них открывающие напряжения привязаны к логическим уровням. У них правда есть один недостаток — их порой сложно достать. Если обычные мощные полевики уже не являются проблемой, то управляемые логическим уровнем бывают далеко не всегда. Для MOSFET-транзистора в корпусе СМД название можно расшифровать
по маркировке: СМД-коды 🔗.
Для MOSFET-транзистора в корпусе СМД название можно расшифровать
по маркировке: СМД-коды 🔗.